TSMC продолжит расширять мощности по упаковке чипов методом CoWoS даже в 2026 году
Для сегмента ускорителей вычислений, используемых в составе систем искусственного интеллекта, способность TSMC упаковывать достаточное количество чипов методом CoWoS имеет огромное значение, поскольку в случае с производством решений Nvidia остаётся «узким местом». Тайваньский производитель намерен активно расширять профильные мощности не только в следующем, но и в 2026 году.
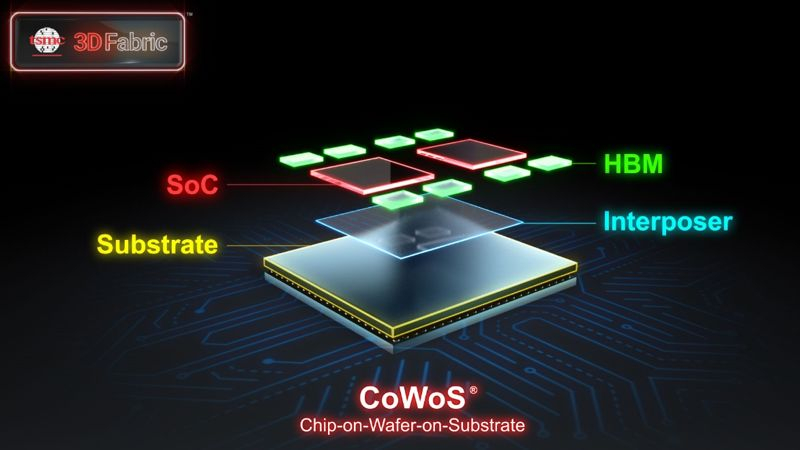
Источник изображения: TSMC
По крайней мере, генеральный директор и председатель совета директоров TSMC Си-Си Вэй (C.C. Wei) пояснил, что в текущем году способности компании по упаковке чипов методом CoWoS вырастут более чем в два раза по сравнению с прошлым годом, и в следующем могут также удвоиться. Не исключено, по словам главы компании, что даже таких темпов экспансии не хватит для удовлетворения спроса на профильные услуги TSMC.
Если говорить об экономике процесса, то сейчас TSMC получает не более 10 % выручки от оказания услуг по упаковке чипов, и в ближайшие пять лет данный сегмент будет расти быстрее прочих направлений деятельности компании. Пока ему не удаётся по норме прибыли достичь средних по всем сегментам показателей, но разница уже не так велика. Свою долю на мировом рынке услуг по упаковке чипов TSMC оценивает примерно в 30 %.
По информации Money DJ, компания TSMC уже разместила заказы на оборудование, которое ей потребуется для упаковки чипов, сроком до 2026 года включительно. Если к концу текущего года TSMC сможет ежемесячно обрабатывать по 40 000 кремниевых пластин в эквивалентном выражении на направлении упаковки чипов методом CoWoS, то в следующем году объём удвоится до 80 000 штук в месяц. К 2026 году темпы экспансии могут замедлиться, расположившись в диапазоне от 100 до 120 тысяч пластин в месяц. Однако, при наличии спроса эти показатели легко могут вырасти до 140 или 150 тысяч пластин в месяц.
