⇣ Содержание

|
Опрос
|
реклама
Самое интересное в новостях
Направляемая самосборка (DSA): не взамен EUV, но очень кстати
Когда больше десяти лет назад, в конце 2014-го, ведущие специалисты мира по прикладным полупроводниковым производствам из IBM, ASML, Imec, Applied Materials и прочих компаний сопоставимого уровня вели жаркие споры о том, насколько «жизнеспособна» (viable) технология EUV, только начинавшая тогда перебираться в цеха из лабораторий, среди прочих средств усовершенствовать глубокую ультрафиолетовую литографию (DUV) с длиной волны 193 нм частенько упоминали направляемую самосборку; directed self-assembly (DSA). Известны различные разновидности этого метода — с опорой в качестве основной движущей вещество силы на поверхностное натяжение разнородных жидкостей, или на силу тяжести, или на магнитные поля, — но микроэлектронщики обращали тогда основное внимание на DSA с участием особого рода полимеров. Суть в том, что на кремниевой пластине-заготовке сперва формируют достаточно крупномасштабную направляющую структуру — pre-pattern, для чего вполне годятся сравнительно недорогие и в избытке доступные на рынке DUV-установки. А затем уже на эту структуру осаждается фоторезист, содержащий блоксополимеры — цепочки макромолекул из чередующихся ковалентно связанных полимерных блоков (субцепочек мономеров) различного состава. 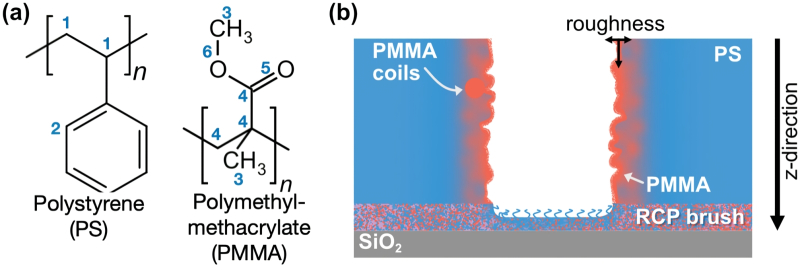
(a) — структурные формулы полистирола и полиметилметакрилата; (b) — схема поперечного сечения тонкой плёнки PS-b-PMMA, которая на подложке из двуокиси кремния, нейтрализованной RCP, формирует два PS-домена (источник: doi.org/10.1002/admi.202200962) В пример можно привести двухкомпонентый блоксополимер — диблоксополимер — из полиметилметакрилата и полистирола; PS-b-PMMA, poly(styrene-block-methyl methacrylate). Два его компонента, обладая существенно различными поверхностными энергиями (бытовой пример столь же разнородных в этом смысле веществ — вода и масло), взаимно отталкиваются. На нейтральной по физико-химическим характеристикам подложке они формировали бы узкие, изогнутые чередующиеся структуры — домены, — образованные либо чистым полиметилметакрилатом, либо полистиролом и схожие по морфологии с папиллярными узорами. Для направляемой же самосборки подложку предварительно размечают, применяя или химический способ (chemoepitaxy; с осаждением «дорожек» вещества, к которому тяготеет один из компонентов диблоксополимера в соответствии со своей поверхностной энергией), или физический (graphoepitaxy; с протравливанием соответствующих канавок). И когда по завершении предварительной процедуры на подготовленную подложку наносится блоксополимер, он формирует хорошо выраженные геометрические образования — приподнятые над поверхностью линии, разрывы между ними, колодцы с кольцевыми брустверами и т. д. Притом, используя для нанесения направляющей структуры 193-нм лазеры, при помощи DSA в лабораториях уже удаётся достигать физического минимального расстояния между центрами соседних металлических дорожек в 12,5 нм (и теоретически это не предел) — тогда как для EUV-техпроцесса с маркетинговым наименованием «3 нм» соответствующая величина составляет 24 нм. Звучит более чем заманчиво; только отчего-то и TSMC, и Samsung, и Intel продолжают тратить многие сотни миллионов долларов США на EUV-установки — и что-то не выражают готовности простимулировать ускоренное появление явно более щадящих по цене DSA-усиленных агрегатов DUV. Что же тормозит развитие столь перспективной технологии? 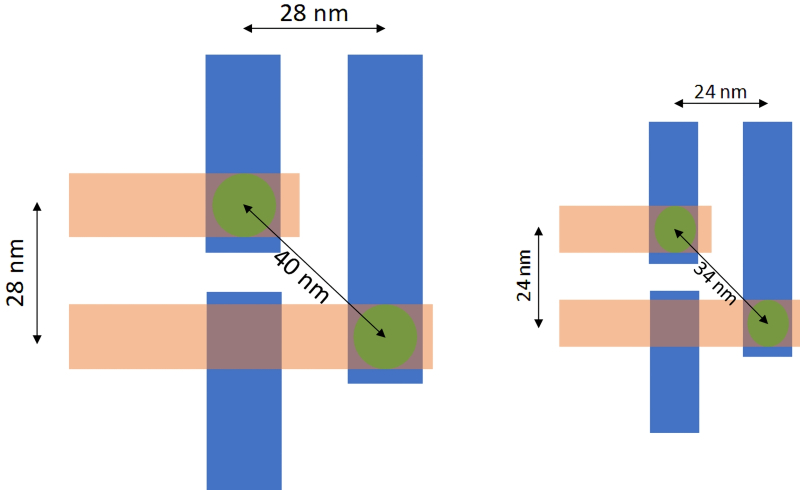
Слева: для «5-нм» техпроцесса физическое расстояние между срединными линиями соседних металлических шин составляет 28 нм, и потому, когда организуется соединение между проводниками в лежащих один над другим таких слоях, дистанция между центрами сквозных каналов достигает уже 40 нм. Справа — та же структура, но для «3-нм» техпроцесса: в одном слое расстояние между осевыми линиями проводников — 24 нм, а между центрами межслойных соединений — уже 34 нм (источник: Proc. SPIE) ⇡#Определённо лучше!Начнём всё же с обоснования перспективности: DSA заведомо выигрывает у классической EUV-литографии хотя бы по такому ключевому параметру, как средняя плотность дефектов на единицу площади изготавливаемой микросхемы. О том, почему миниатюризация технологических норм ниже порога «5 нм» провоцирует более частое появление таких дефектов, мы уже писали. Суть в том, что для успешной «засветки» фоторезиста на определённом участке нужно передать этому участку некоторое количество энергии. Чем короче длина волны излучения, падающего на фоторезист, тем каждый отдельный фотон высокоэнергичнее — и тем, соответственно, их нужно меньше для достижения необходимого эффекта. Но когда число фотонов, нужных для экспонирования участка тончайшего элемента полупроводниковой схемы, исчисляется уже буквально десятком-полутора, во всей красе проявляет себя паразитная стохастика: один-единственный сильно (но всё ещё в пределах статистической погрешности) отклонившийся от курса квант электромагнитного излучения способен исказить формируемую на подложке геометрическую структуру — и тем самым ощутимо понизить качество изготавливаемого полупроводникового наноприбора. Для техпроцесса «5 нм» стохастические эффекты EUV-процесса оборачиваются высокой вариативностью рабочих характеристик создаваемых на поверхности кремниевой заготовки транзисторов, а начиная с «3 нм» входящие не в те двери фотоны порождают сравнимые с габаритами самих этих транзисторов изъяны — разрывы токоведущих дорожек, слияния соседних контактов и т. п. В результате при серийном выпуске тех же «3-нм» микросхем до половины всех производственных дефектов порождает именно фотонная стохастика. Важно понимать, что с уменьшением характерных размеров отдельных полупроводниковых элементов роль случайных эффектов только нарастает: индетерминизм — имманентное свойство квантовых систем, и «сфокусировать» каким-то образом поток единичных почти что рентгеновских фотонов (с длиной волны 13,5 нм) так, чтобы отдельные его представители заметно не отклонялись от заданного пучку общего направления, физически невозможно. В то же время несовершенства технологии DSA — из-за которых, собственно, десять лет назад от неё и отступились как от магистрального пути развития микроэлектронных производств, — носят по большей части технический характер и потому вполне преодолимы. Более того, изживать эти недостатки возможно не в параллель с развитием классической на сегодня EUV-фотолитографии, т. е. не изыскивая на это отдельные бюджеты, а совместно с ней; применяя направляемую самосборку для коррекции тех самых неотвратимых стохастических дефектов, что становятся бичом технологических процессов вблизи маркетингового «нанометрового» порога. При таком подходе сформированные в ходе EUV-экспонирования и травления структуры становятся направляющими для полимерных цепочек с DSA — и уже поверх тех (скрывающих стохастически обусловленные изъяны EUV-паттернинга, словно штукатурка — огрехи не слишком ровной кладки) на следующих этапах создания полупроводниковой схемы производится осаждение очередного слоя. 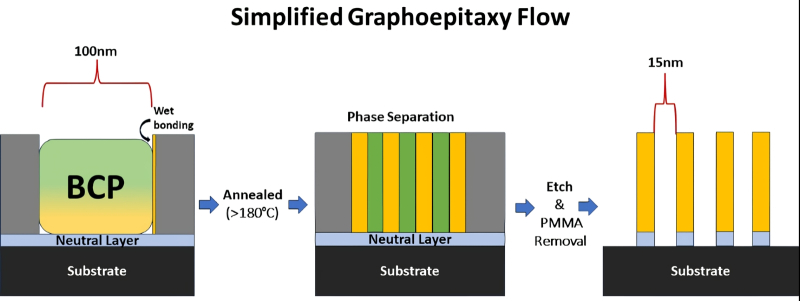
Упрощённая схема графоэпитаксиальной направляемой самосборки, которая позволяет на сформированных методами классической литографии заготовках с характерным шагом в 100 нм получать высокоупорядоченные структуры с зазорами в 15 нм между соседними элементами (источник: Semiconductor Engineering) В чём же заключается подвох; что именно с направляемой самосборкой может идти не так? В какой-то мере и здесь проявляет себя стохастика — только уже на этапе формирования молекул блоксополимера. Такие молекулы состоят из чередующихся гидрофильных и гидрофобных блоков: как раз силы взаимного отталкивания между этими фрагментами и позволяют формировать ровные (не склонные самопроизвольно перегибаться и запутываться) протяжённые «нити» минимальной толщины. Чем больше разница поверхностных энергий между соседними блоками, тем короче могут быть эти самые блоки, не теряя своих химических свойств, и, следовательно, тем меньше характерный размер структур, которые удастся создавать в процессе DSA с применением таких молекул. Однако если поверхностные энергии окажутся слишком уж различны, ковалентным связям между блоками труднее будет противодействовать взаимному отталкиванию, что станет приводить к разрывам цепочек и к нарушениям упорядоченности блоксополимерных мезоструктур. И хотя химические способы производства в целом эффективнее физических (если удаётся отыскать, отладить и поставить на поток процесс выращивания определённых молекул в промышленных объёмах, это выходит куда дешевле и проще, чем добиваться схожих целей прецизионно-инженерными средствами), полимерная химия тоже бросает исследователям множество вызовов. И далеко не со всеми ними разработчики готовы были справляться, пока торная дорога развития микроэлектронных производств — EUV-фотолитография — требовала, как казалось, по большей части экстенсивного наращивания усилий, практически гарантируя в итоге результат благодаря пресловутому «закону Мура». ⇡#В практической плоскостиКак уже упоминалось, известны два способа нанесения на кремниевую подложку блоксополимерных DSA-структур: графо- и хемоэпитаксия. Графоэпитаксия предусматривает предварительную разметку поверхности методами классической фотолитографии, но с разрешением, кратно (в 2-5 раз) превосходящим целевое, которое должно определять характерный размер уже конечных полупроводниковых структур. Полученные в ходе такой разметки «траншеи» заполняют блоксополимером, который после отжига (нагревания выше 180 °С) испытывает разделение фаз. Причём характерный размер блоков PS-b-PMMA (если рассматривать именно этот диблоксополимер) и определяет физический параметр pitch — расстояние между центрами соседних элементарных структур получаемой в итоге микросхемы. Здесь имеется ряд технологических тонкостей (дно «траншей» не должно взаимодействовать ни с одним из компонентов диблоксополимера; на одной же из стенок, напротив, обязано присутствовать покрытие, которое сформирует прочную связь с одним из этих компонентов), но в целом всё достаточно последовательно и просто. У хемоэпитаксиального подхода — своя особенность: здесь для формирования «столбиков» из чередующихся компонентов диблоксополимера предварительно создают направляющую разметку, где точно так же чередуются области с разными значениями поверхностной энергии — к которым будут затем естественным образом крепиться соответствующие молекулярные блоки. Сперва подложку покрывают тонким слоем полистирола, после чего опять-таки характерными для фотолитографического процесса методами производят его выборочное (с маскированием) травление, добавляют блоксополимер, удаляют полиметилметакрилат — и протравливают полученную структуру уже до основы. И в этом случае физическое разрешение техпроцесса DUV+DSA в несколько раз превосходит таковое для достижимого на одном только DSA-оборудовании и вполне сопоставимо с тем, что обеспечивают EUV-установки (по крайней мере, не High-NA, а первого поколения, рассчитанного на «5 нм» и «3 нм»). Как знать — информация эта, ясное дело, закрытая, — быть может, достигнутыми за последний год успехами в освоении «7-нм» техпроцесса (с серьёзной заявкой на «5 нм») на DUV-оборудовании полупроводниковая промышленность КНР обязана как раз направляемой самосборке на финальном этапе технологической цепочки? По крайней мере, именно китайские исследователи проявляют к теме DSA в последнее время особый интерес. В зависимости от соотношения длин молекулярных цепочек полистирола (PS) и полиметилметакрилата (PMMA) в составе диблоксополимера получают и различные геометрические структуры на плоскости. Примерно равные по длине цепи позволяют создавать параллельные ряды высоких и тонких пластин, что прекрасно годятся для формирования гребней транзисторов FinFET, к примеру. Варьируя же соотношение длин мономеров PS и PMMA, удаётся организовывать упорядоченные цилиндрические структуры — которые затем могут становиться основой для «колодцев» ячеек памяти NAND. Это, конечно же, самые базовые закономерности DSA-процесса; использование различных полимеров, процедур и многослойного подхода ещё более расширяет возможности экспериментаторов. Особенно же радует исследователей тот факт, что, даже в отсутствие сверхточного исполнения направляющей структуры, самосборные блоксополимеры всё равно будут — просто в силу закономерностей химической физики — выстраиваться в весьма близкие к идеальным упорядоченные конфигурации. С этой точки зрения хемоэпитаксиальный подход представляется даже более предпочтительным: хотя времени и усилий он требует больше, здесь нет столь жёстких требований к физическим размерам предварительно прокладываемых «траншей» и к точному нанесению на выделенные их стенки определённых химикатов. 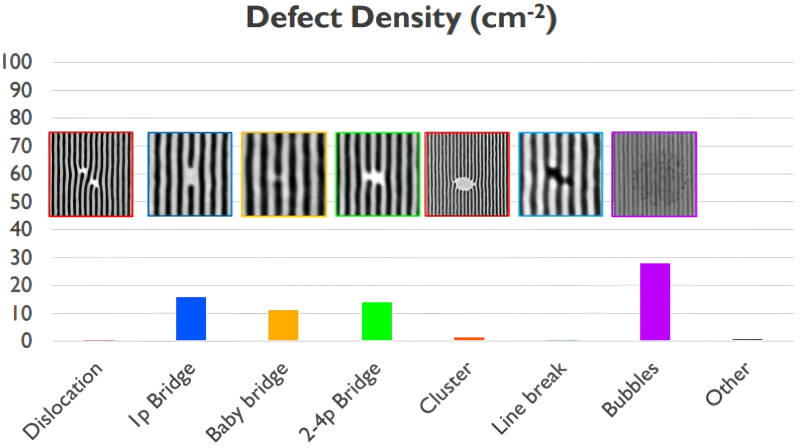
Плотность (ед./кв. см) дефектов различного типа — как именно они выглядят, поясняют картинки сверху — для DSA-процесса на «13-нм» фотолитографированной направляющей структуре (источник: Imei) На этой оптимистической ноте вернёмся к заданному в самом начале вопросу: что же мешает применять DSA как можно более широко — пусть не взамен EUV, но хотя бы в помощь тем вполне функциональным DUV-фотолитографам, что уже сегодня могли бы подключиться к выпуску так нужных рынку чипов (в особенности DRAM и NAND) по более миниатюрным производственным нормам? Увы, в полупроводниковой индустрии степень совершенства той или иной технологии обычно пропорциональна её возрасту, а DSA совсем молода: всерьёз на неё как на жизнеспособную технологию обратили внимание, напомним, лишь в начале 2000-х. Та же замечательная во всех отношениях хемоэпитаксия, например, ощутимо страдает от нехватки отлаженных способов получения необходимых ей химикатов высочайшей степени очистки; со строго постоянными для каждого участка полимерных цепей и субстратов, на которые те в итоге осаждаются, значениями поверхностной энергии. Достаточно сказать, что в микроэлектронном производстве индустриальный стандарт приемлемого технологического процесса подразумевает стабильный уровень появления дефектов на обрабатываемой заготовке менее одной единицы на 1 см². У DSA же только различных типов производственных изъянов наберётся с десяток, и для каждого из них число дефектов на квадратный сантиметр может достигать чуть ли не 30. Буквально на каждом этапе — выдерживание заданной температуры отжига, обеспечение строго заданной толщины осаждаемых на подложку тонких плёнок по всей из площади, химическая активность принимающих участие в процедуре травления веществ и проч. — этот тонкий процесс уязвим для малейших колебаний рабочих параметров, что и выражается в появлении столь значительного числа дефектов. ⇡#И всё-таки она выравниваетсяПомимо высокой пока что плотности дефектов (а исправление этой детской болезни, в отличие от квантовой стохастики высокоэнергичных EUV-фотонов, — дело наживное, как мы уже упоминали), перед DSA стоит ещё одна практическая проблема. А именно, она отлично подходит для формирования строго упорядоченных структур, будь то ровные гребёнки узких «плавников» или безупречно выстроенные в узлах квадратной решётки цилиндрические отверстия. Но логические схемы подразумевают куда более сложное взаимное расположение компонентов, когда между одной парой соседних элементов расстояние должно быть одним, а между другой — существенно иным. В этом случае DSA именно как недорогой, химический (в противоположность фотолитографическому, инженерному) способ массового изготовления миниатюрных структур откровенно пасует. Утешительно, конечно, что для чипов памяти столь высокая упорядоченность полупроводниковых компонентов, достигаемая по сути автоматически, без использования сложных приборов и установок, — настоящее спасение. Это опять-таки позволяет надеяться, что изготовители памяти DRAM, которым в любом случае придётся в ближайшие годы спешно расширять производственные мощности, не поскупятся проинвестировать в развитие столь экономичного (в перспективе, когда его доведут-таки до ума) способа продлить фактический срок эксплуатации объективно вроде бы устаревающих станков DUV. 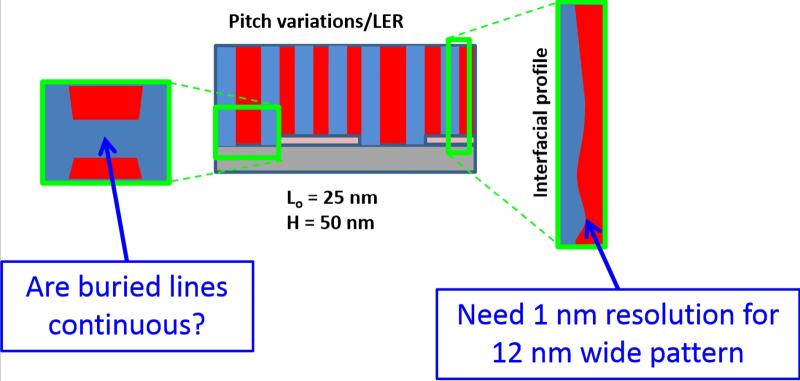
В толще сформированной методом DSA структуры могут возникать — и, увы, на практике действительно возникают — разнообразные дефекты, обнаружить которые не так-то просто (источник: NIST) Ещё одна, уже не столь очевидная, загвоздка с DSA, возникает на этапе исследования и верификации полученной с использованием этого метода заготовки. Блоксополимеры, даром что физические свойства их компонентов (поверхностная энергия) различаются кардинально, формируют крайне малоконтрастные для внешнего наблюдателя поверхности, что неимоверно затрудняет их метрологические исследования. Стандартный инструментарий для дефектоскопирования полупроводников — просвечивающая электронная микроскопия, дифракция рентгеновских лучей — не позволяет эффективно различать границы между компонентами диблоксполимерного сэндвича в его объёме, что грозит некорректной оценкой работоспособности полученных таким образом микросхем. Ведь слоистая структура растёт в трёх измерениях, и даже если на поверхности наблюдается строго упорядоченное чередование полос равной ширины, в толще слоя вполне возможно отклонение от вертикали (когда в сечении выходит не прямоугольник, а клин), не говоря уже об опасности появления разрывов, — и на физических свойствах сформированного таким образом полупроводника то и другое, бесспорно, скажется. Так или иначе, период выхода DSA из лабораторий в производственные цеха, судя по всему, надолго не затянется. Интерес к этой технологии ещё в 2024 г. начала проявлять сама Intel — вскоре после того, как выяснилось, что у спешно закупленных ею новейших и запредельно дорогих фотолитографов High-NA EUV (380 млн долл. США за штучку, будьте добры; нет, переводы через СБП не принимаем) себестоимость обработки заготовки за один проход выше, чем у EUV-машины первого поколения, работающей в два прохода. И хотя с техпроцессом «18A» у американского чипмейкера действительно не слишком задалось, перспективный «14A» потенциальных заказчиков очень даже впечатлил — не в последнюю очередь, видимо, потому, что его органичной частью как раз и стал фирменный вариант направляемой самосборки, SALELE (Self-Aligned Litho-Etch Litho-Etch). О нём Intel объявила в начале 2024 г., на мероприятии SPIE Advanced Lithography & Patterning: именно в комбинации с DSA-выправлением не слишком аккуратных, надо полагать, линий, формируемых при экспонировании заготовки высокоэнергичными EUV-фотонами, удаётся формировать на подложке элементы полупроводниковых устройств на расстоянии 18-21 нм один от другого. 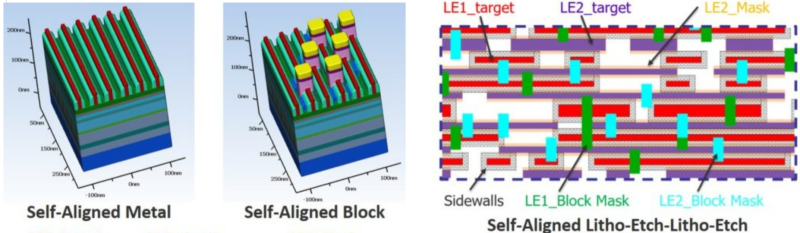
SALELE, наряду с SADP и SAQP, входит в число активно развиваемых сегодня полупроводниковой индустрией производственных процессов с самовыравниванием (источник: Siemens) Строго говоря, такой (вполне логичный) подход к совершенствованию классической фотолитографии в маркетинговом диапазоне «1-2 нм» инженеры-микроэлектронщики развивают не первый год. Ещё первые литографы EUV (сегодня, говоря о них, добавляют уточняющее определение «Low-NA», чтобы отличать от наиболее актуальных) реализовывали двойной паттернинг с самовыравниванием — self-aligned double patterning, SADP, который, в свою очередь, стал развитием самого раннего варианта двухпроходной литографии — последовательности действий «литография — травление — литография — травление» (lithography-etching-lithography-etching; LELE). Так что большим секретом технология SALELE (возможно, за исключением самой аббревиатуры, указывающей на творческое переосмысление исходного процесса LELE) для специалистов не оказалась. Важным, однако, стало подтверждение, что применение её как повышает выход годных кристаллов с пластины по сравнению с традиционными методами, так и увеличивает производительность всей процедуры, снижая тем самым итоговую себестоимость готового чипа. Не раскрывая, конечно, всех технологических деталей, представители Intel дали понять, что одна процедура SALELE с применением High-NA EUV заменяет три, а то и четыре операции в режиме Low-NA. В результате даже с учётом более высокой себестоимости самой этой процедуры (она существенно многоступенчатая, требует специальных химикатов, целого набора фотомасок и т. д.) выгода от замены ею сразу нескольких более дешёвых операций налицо. Словом, DSA понемногу проникает в серийную фотолитографию; причём, похоже, её используют как для удешевления производства на самой передовой технике (High-NA EUV), так и для расширения возможностей формально сходящей со сцены (DUV). С учётом того, насколько сегодня велик спрос на чипы — и различных видов памяти, и логические, в особенности ориентированные на решение ИИ-задач, — в обозримом будущем развитие направляемой самосборки пойдёт, судя по всему, с заметным ускорением. Если Вы заметили ошибку — выделите ее мышью и нажмите CTRL+ENTER.
|