Размеры современных процессоров обычно невелики, но крупнейший в мире контрактный производитель полупроводников TSMC разрабатывает новый вариант своей технологии упаковки чипов CoWoS, с помощью которой можно будет создавать конструкции площадью до 9,5 размеров фотомаски (7885 мм²) на подложках размером 120 × 150 мм (18 000 мм²). Производительность таких гигантов в 40 раз превысит показатели современных процессоров. Но и это не предел.
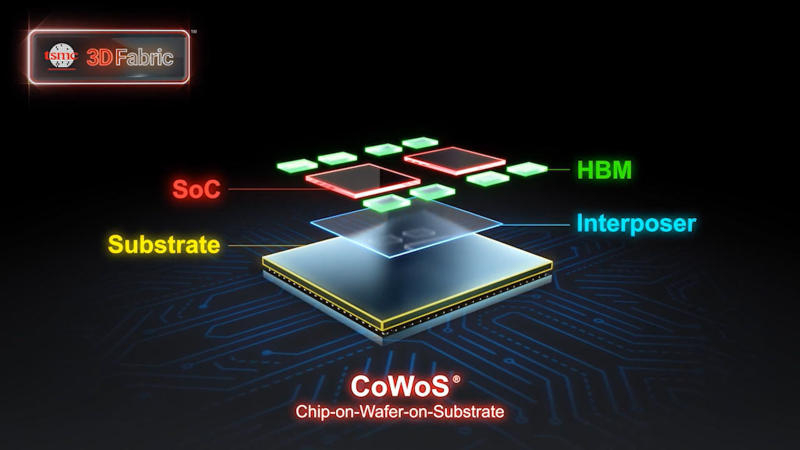
Источник изображений: TSMC
Практически все современные высокопроизводительные процессоры, предназначенные для работы в центрах обработки данных, уже имеют многочиплетное строение. С ростом спроса на более быстрые решения разработчики стремятся интегрировать в свои системы ещё больше кремния. Стремясь удовлетворить этот спрос, TSMC расширяет свои возможности по упаковке чипов и делает их ещё крупнее. На своём мероприятии North American Technology Symposium компания продемонстрировала дорожную карту 3DFabric: интерпозеры вырастут далеко за рамки возможностей современных технологий.
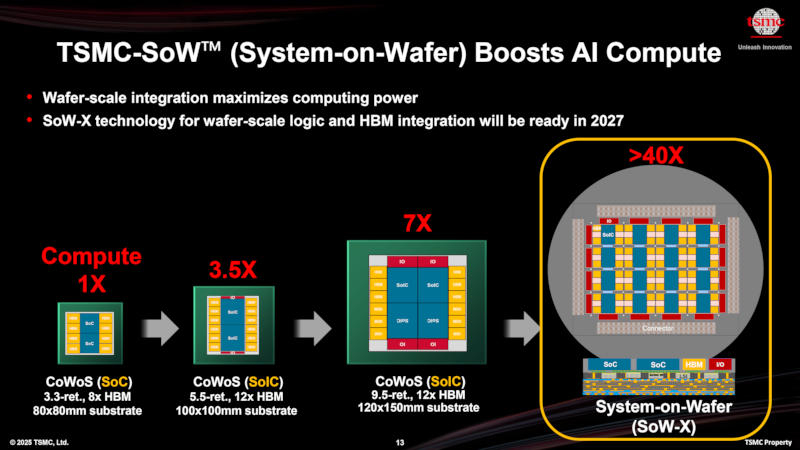
Актуальная версия технологии упаковки TSMC CoWoS позволяет применять интерпозеры площадью до 2831 мм² — это в три раза больше предельного размера фотомаски: стандарт сверхжёсткой ультрафиолетовой литографии (EUV) составляет 858 мм², а TSMC использует 830 мм². Этого предела уже достигли ускорители искусственного интеллекта AMD Instinct MI300X и NVIDIA B200 с двумя большими логическими чиплетами и восемью стеками памяти HBM3 или HBM3E. Однако для будущих процессоров этого уже недостаточно. В следующем году или немного позже TSMC представит новую технологию упаковки CoWoS-L с поддержкой интерпозеров площадью до 4719 мм² — это примерно в 5,5 раза больше стандартной площади фотомаски. Такая упаковка будет включать до 12 стеков памяти и потребует более крупной подложки размером 100 × 100 мм (10 000 мм²). Решения, построенные на такой архитектуре, позволят втрое повысить вычислительную производительность по сравнению с текущими разработками. Этого хватит, например, для ускорителей NVIDIA Rubin с 12 стеками HBM4, но наращивание мощности потребуется и в дальнейшем.
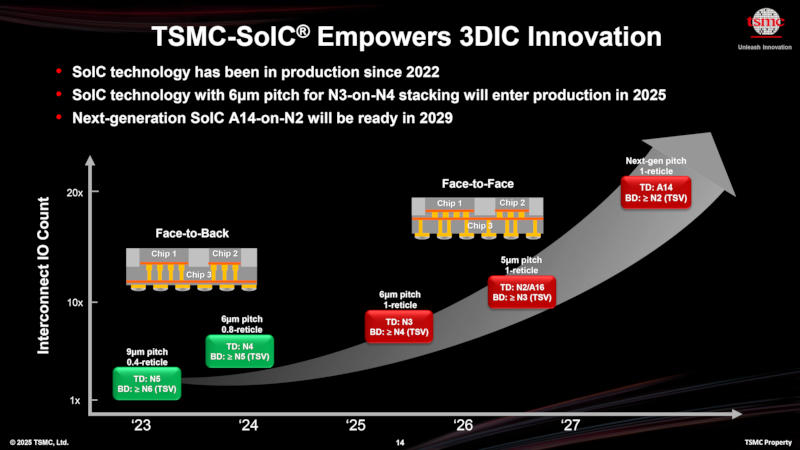
В перспективе TSMC намерена предложить клиентам интерпозеры площадью до 7885 мм² — в 9,5 раза больше максимально возможной фотомаски, — размещаемые на подложке размером 120 × 150 мм. Для сравнения, стандартный размер коробки для компакт-диска составляет примерно 125 × 142 мм. В прошлом году компания говорила о многочиплетных конструкциях размером 120 × 120 мм (примерно в восемь раз больше фотомаски), и рост этого показателя, по-видимому, отражает потребности клиентов. Такая конструкция будет включать четыре компонента с вертикальной установкой кристаллов SoIC (например, кристалл N2 или A16 поверх логики N3), двенадцать стеков HBM4 и дополнительные кристаллы ввода-вывода.
У TSMC есть клиенты, которым требуется максимально возможная производительность, и они готовы за неё платить. Для них компания предлагает технологию System-on-Wafer (SoW) — производство чипов размером с кремниевую пластину. Пока этой возможностью воспользовались только Cerebras и Tesla, но в TSMC уверены, что к ним присоединятся и другие клиенты. Обновлённая технология SoW-X, основанная на CoWoS, позволит создавать многокристальные ИИ-ускорители размером с полупроводниковую пластину, на которую можно будет установить HBM-память и оптические соединения. Внедрение SoW-X запланировано на 2027 год.
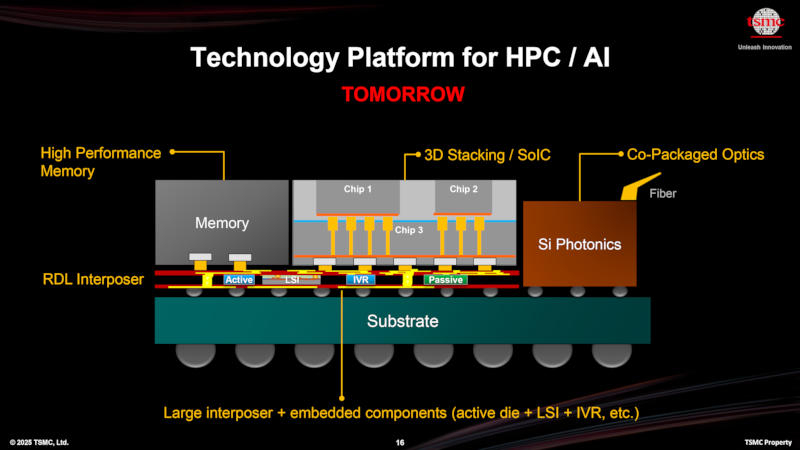
Процессоры размером в 9,5 площадей маски или даже размером с пластину требуют значительных усилий в производстве и сборке. Одним из главных вопросов остаётся подача питания: такие чипы требуют киловаттных мощностей и высокого тока. Производителям серверов становится всё сложнее решать эту проблему самостоятельно, поэтому справляться с ней придётся на уровне системы. TSMC предлагает интегрировать в корпуса CoWoS-L с интерпозерами RDL (Redistribution Layer) монолитные интегральные схемы управления питанием (PMIC) со сквозными вертикальными межсоединениями (TSV), изготовленные по технологии N16 FinFET, и встроенные на пластине индукторы. Это позволит прокладывать питание через подложку, сократив расстояние между источниками питания и активными кристаллами, что, в свою очередь, уменьшит паразитное сопротивление и улучшит целостность питания в системе.
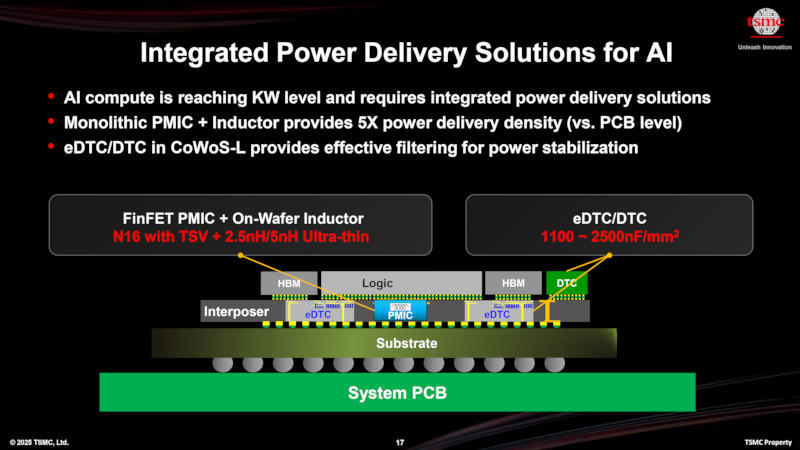
PMIC, изготовленные с использованием технологии N16, позволяют точнее контролировать подачу питания к процессорам, утверждает TSMC. Это особенно важно в условиях многоядерных и многокристальных конструкций, где рабочие нагрузки могут меняться быстро, но необходимо поддерживать стабильную работу системы. Схема обеспечивает тонкую регулировку при динамическом масштабировании напряжения (DVS) с заданной величиной тока; по сравнению с традиционными подходами плотность подачи мощности возрастает пятикратно. Встроенные в интерпозер или кремниевую подложку глубокотраншейные конденсаторы (eDTC/DTC) обеспечивают высокую плотность развязки до 2500 нФ/мм² и повышают стабильность питания вблизи кристалла, обеспечивая его надёжную работу даже при быстрых изменениях нагрузки. Такая схема повышает эффективность DVS и улучшает переходные характеристики — оба эти фактора крайне важны для управления энергоэффективностью в сложных многоядерных и многокристальных системах. Подход TSMC отражает сдвиг в сторону оптимизации на уровне системы: подача питания теперь рассматривается как неотъемлемая часть кремния, упаковки и всей конструкции, а не отдельная функция каждого компонента.
Увеличение размеров интерпозера повлечёт последствия для проектирования системы — в частности, с точки зрения форм-фактора упаковки. Подложка размером 100 × 100 мм почти достигает предела формата OAM 2.0 (102 × 165 мм); перспективная подложка 120 × 150 мм уже превышает его, и, вероятно, потребуется внедрение новых стандартов для упаковки модулей и компоновки плат. Кроме того, такие системы в упаковке (System-in-Package, SiP) выделяют огромное количество тепла. Для решения этой проблемы производители уже изучают новые методы охлаждения, включая прямое жидкостное охлаждение, которое применяет NVIDIA в GB200/GB300 NVL72, а также технологии иммерсионного охлаждения, которые помогут справиться с тепловыделением процессоров мощностью в несколько киловатт. И эту задачу TSMC не сможет решить на уровне чипа или SiP — по крайней мере, пока.
Источник:


 MWC 2018
MWC 2018 2018
2018 Computex
Computex
 IFA 2018
IFA 2018














