Компания Samsung Electronics создала рабочую группу по разработке новых технологий упаковки полупроводников, которая займётся, в том числе, расширением сотрудничества с крупными компаниями, занятыми в этой сфере. Эта группа, сформированная бизнес-подразделением Device Solutions (DS) в середине июня, находится в прямом подчинении возглавляющему DS гендиректору Samsung Кюн Ки Хёну (Kyung Kye-hyun).
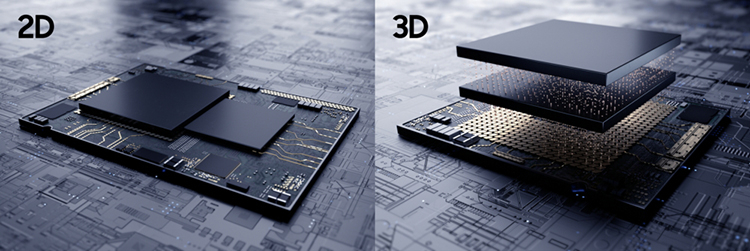
Источник изображения: Samsung
В новую группу вошли инженеры команды Test & System Package (TSP) подразделения DS, специалисты Центра исследований и разработок полупроводников, а также сотрудники подразделений Samsung по производству памяти и других чипов. Перед группой поставлена задача предложить передовые решения по упаковке полупроводников.
Этот шаг показывает, какое значение Кюн Ки Хён придаёт передовым технологиям упаковки полупроводников. В настоящее время, когда миниатюризация микросхем приближается к своим пределам, набирают популярность технологии 3D-упаковки, позволяющие объединить микросхемы, изготовленные с использованием разных техпроцессов, в единый чип.
Глобальные полупроводниковые гиганты, такие как Intel и TSMC, активно инвестируют в разработку технологий усовершенствованной упаковки чипов. По данным исследовательской фирмы Yole Development, в 2022 году на долю Intel и TSMC приходится соответственно 32 % и 27 % глобальных инвестиций в разработку передовых технологий упаковки полупроводников. По уровню инвестиций в этой сфере Samsung Electronics занимает четвёртое место после ASE, тайваньской компании, занимающейся упаковкой и тестированием интегральных схем.
Intel использует для производства чипов технологию пространственной упаковки Foveros. В частности, с её помощью был изготовлен процессор Lakefield, вышедший в 2020 году, который нашёл применение в ноутбуках Samsung Electronics. Также 3D-упаковку чипов уже использует TSMC при изготовлении процессоров для компании AMD.
Samsung также активно работает над этим направлением. В 2020 году южнокорейская компания представила технологию X-Cube для 3D-упаковки чипов памяти с расположением ОЗУ SRAM на кристалле логики или центральном процессоре. А президент и глава подразделения по производству чипов Чой Си Ён (Choi Si-young) заявил на ежегодной конференции Hot Chips 2021, что компания разрабатывает «3,5D-упаковку» чипов.
Источник:


 MWC 2018
MWC 2018 2018
2018 Computex
Computex
 IFA 2018
IFA 2018

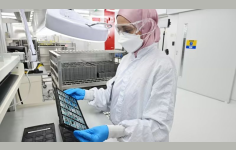





 «Гравитон» начал производство российских твердотельных накопителей
55
«Гравитон» начал производство российских твердотельных накопителей
55
 Ветеран NASA разработал бестопливный ракетный двигатель, который работает на «новой силе»
41
Ветеран NASA разработал бестопливный ракетный двигатель, который работает на «новой силе»
41
 Космический зонд «Вояджер-1» впервые за пять месяцев отправил на Землю читаемые данные
38
Космический зонд «Вояджер-1» впервые за пять месяцев отправил на Землю читаемые данные
38
 МКС стала рассадником устойчивых к антибиотикам бактерий-мутантов
33
МКС стала рассадником устойчивых к антибиотикам бактерий-мутантов
33
 Подписаться
Подписаться