
|
Опрос
|
реклама
Быстрый переход
Nvidia App получило обновление, которое исправило замедление игр — «тормозящие» фильтры теперь отключены по умолчанию
24.12.2024 [15:01],
Павел Котов
Nvidia подтвердила наличие проблемы с производительностью в программном пакете Nvidia App и предложила его решение — отключить опцию «Игровые фильтры». В очередном обновлении компания отчасти решила эту проблему, отключив опцию по умолчанию. 
Источник изображения: nvidia.com Nvidia App позиционируется как замена GeForce Experience, которая объединит функции предшественника и в перспективе — панели управления. Новый программный продукт был выпущен несколько месяцев назад и издавался параллельно с основной веткой в качестве бета-версии для геймеров. Но когда Nvidia выпустила его в комплекте с драйверами, пользователи стали замечать просадку производительности. Сообщество выдвинуло множество гипотез происходящего, и впоследствии производитель сообщил, что устранить потерю производительности можно, отключив настройку «Игровые фильтры». В последнем обновлении Nvidia App 11.0.1.189 проблема ещё не решена окончательно, но опция «Игровые фильтры» теперь отключена по умолчанию. Некоторые пользователи сообщали о проблеме ещё на этапе бета-тестирования, из чего можно сделать вывод, что Nvidia не сможет решить её оперативно. Маловероятно, что ошибка будет исправлена до наступления 2025 года. При соответствующих настройках программного пакета он должен автоматически обновиться с очередным запуском. Низкопробный софт AMD не даёт раскрыть потенциал ИИ-ускорителей Instinct MI300X и обойти Nvidia, выяснили эксперты
23.12.2024 [23:11],
Николай Хижняк
Пятимесячное расследование компании SemiAnalysis показало, что специализированные ИИ-ускорители серии AMD MI300X не раскрывают свой потенциал из-за серьёзных проблем в работе программного обеспечения. Этот факт делает все усилия компании по навязыванию жёсткой конкуренции Nvidia, доминирующей на рынке аппаратного обеспечения для ИИ, бессмысленными. 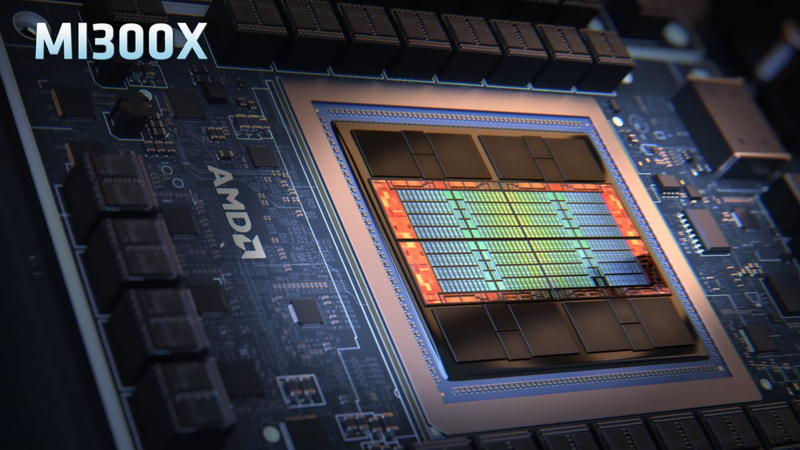
Источник изображения: The Decoder Исследование показало, что программное обеспечение AMD изобилует ошибками, которые делают обучение моделей ИИ практически невозможным без значительной отладки. Таким образом, пока AMD работает над обеспечением качества и простоты использования своих ускорителей, Nvidia продолжает увеличивать разрыв, развёртывая новые функции, библиотеки и повышая производительность своих решений. По итогам обширных тестов, включая тесты GEMM и одноузловое обучение, исследователи пришли к выводу, что AMD не в состоянии преодолеть то, что они называют «неприступным рвом CUDA» — сильное преимущество в виде программного обеспечения, которым обладают ускорители Nvidia. 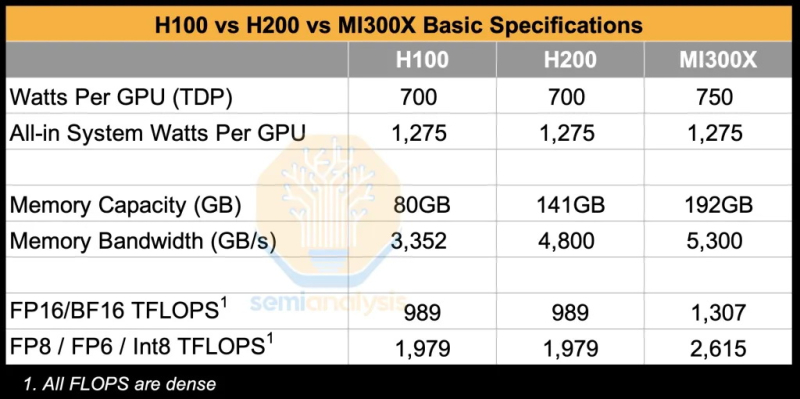
Источник изображения: SemiAnalysis AMD MI300X «на бумаге» выглядят впечатляюще: 1307 Тфлопс в вычислениях FP16 и 192 Гбайт памяти HBM3. Для сравнения, ускорители Nvidia H100 обладают производительностью 989 Тфлопс и имеют только 80 Гбайт памяти. Однако новое поколение ИИ-ускорителей Nvidia H200 с конфигурациями до 141 Гбайт памяти сокращает разрыв в объёме доступного буфера памяти. Кроме того, системы на базе ускорителей AMD также предлагают более низкую общую стоимость владения благодаря более низким ценам на такие системы и более доступной поддержке сетевой инфраструктуры. 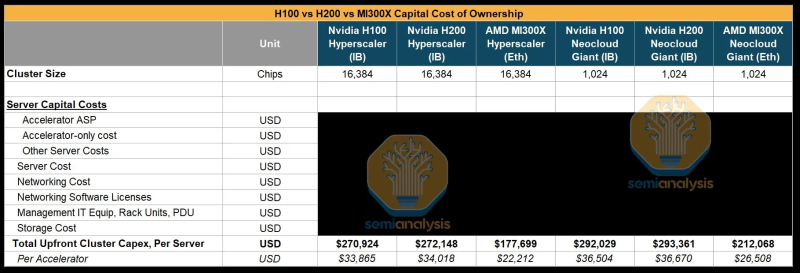
Источник изображения: SemiAnalysis Однако эти преимущества мало что значат на практике. По данным SemiAnalysis, сравнение «голых» спецификаций похоже на «сравнение камер, когда просто проверяешь количество мегапикселей у одной и другой». AMD, отмечают аналитики, таким образом «просто играет с цифрами», но её решения не обеспечивают достаточный уровень производительности в реальных задачах. Исследователи отмечают, что им пришлось напрямую работать с инженерами AMD, чтобы исправить многочисленные ошибки в ПО для получения пригодных для оценки результатов тестов. В то же время системы на базе ускорителей Nvidia работали гладко и без каких-либо дополнительных настроек. «С OOBE от AMD (опыт, который пользователь получает при получении продукта после распаковки или при запуске установщика и подготовке к первому использованию, так называемый "опыт из коробки" — прим. ред.) очень сложно работать. И для перехода к пригодному к использованию состоянию [оборудования] может потребоваться немало терпения и усилий», — пишут эксперты. Особенно показательным для SemiAnalysis оказался случай, когда компания TensorWave, крупнейший поставщик облачных решений на базе графических процессоров AMD, была вынуждена предоставить команде инженеров AMD бесплатный доступ к своим графическим процессорам — тому же оборудованию, которое TensorWave приобрела у AMD — только для устранения проблем с программным обеспечением. Для решения проблем эксперты SemiAnalysis рекомендуют генеральному директору AMD Лизе Су (Lisa Su) более активно инвестировать в разработку и тестирование программного обеспечения. В частности, они предлагают выделить тысячи чипов MI300X для автоматизированного тестирования (аналогичному подходу следует Nvidia для своих ускорителей), упростить сложные переменные среды, одновременно внедрив более эффективные настройки для ускорителей по умолчанию. «Сделайте готовый опыт пригодным к использованию!» — призывают специалисты. Представители SemiAnalysis в своём отчёте признаются, что желают успеха компании AMD в конкуренции с Nvidia, но отмечают, что «к сожалению, для этого ещё многое предстоит сделать». Без существенных улучшений программного обеспечения AMD рискует ещё больше отстать, поскольку Nvidia готовится к массовому выпуску ускорителей нового поколения Blackwell. Хотя, по сообщениям, этот процесс у Nvidia также проходит не совсем гладко. Nvidia устранила микрофризы в Indiana Jones and the Great Circle с помощью драйвера GeForce Hotfix 566.45
23.12.2024 [17:29],
Николай Хижняк
Компания Nvidia выпустила обновление графического драйвера GeForce Hotfix Display Driver 566.45, основанное на версии Game Ready Driver 566.36. Обновление предназначено для исправления определённых проблем в игре Indiana Jones and the Great Circle, а также для повышения стабильности других игр компании Ubisoft, работающих на игровом движке Snowdrop (из последних это Star Wars Outlaws, XDefiant, Avatar: Frontiers of Pandora). 
Источник изображения: VideoCardz Данное обновление не решает проблемы снижающего игровую производительность приложения Nvidia App, о чём ранее сообщали некоторые пользователи видеокарт GeForce. Эти проблемы вызваны функцией оверлея и цветовых фильтров в составе приложения. Ранее Nvidia рекомендовала временно их отключить. Список изменений в GeForce Hotfix Display Driver 566.45:
Отмечается, что драйвер не получил сертификат WHQL и рекомендуется не всем пользователям, а лишь тем, у кого возникают проблемы с микрофризами в указанной игре. Весьма вероятно, что новая стабильная версия драйвера GeForce появится только в следующем году. Скачать GeForce Hotfix Display Driver 566.45 можно отсюда. Евросоюз дал добро на поглощение Nvidia израильского стартапа Run:ai
20.12.2024 [18:56],
Сергей Сурабекянц
Nvidia получила безусловное одобрение Евросоюза на покупку израильского стартапа Run:ai, который разрабатывает платформу для оркестрации нагрузок искусственного интеллекта. Еврокомиссия заявила, что поглощение не представляет угрозы конкуренции в Европе, несмотря на позицию Nvidia как «ведущего производителя ключевого оборудования для приложений ИИ, используемых в ЕС и за его пределами» и расследование Министерства юстиции США.  «Наше исследование рынка подтвердило, что другие варианты программного обеспечения, совместимые с оборудованием Nvidia, останутся доступными на рынке», — заявила глава антимонопольного управления ЕС Тереза Рибера (Teresa Ribera). Компания Run:ai, основанная в 2018 году Омри Геллером (Omri Geller) и Роненом Даром (Ronen Dar), тесно сотрудничает с Nvidia с 2020 года. Условия сделки официально не раскрываются, но израильская газета Calcalist оценила её стоимость в $700 млн. Последней крупной сделкой Nvidia в Израиле было приобретение в 2020 году Mellanox Technologies за $7 млрд. Проверка наблюдательного органа ЕС была инициирована итальянским антимонопольным регулятором в соответствии с особыми полномочиями, которые позволяют Брюсселю расследовать слияния, включая технологические сделки, которые не соответствуют требуемым пороговым значениям выручки для проверок ЕС. Эти полномочия были ограничены Судом ЕС после недавней блокировки поглощения Illumina поставщика услуг по диагностике рака Grail за $7 млрд. По мнению суда, наблюдательный орган ЕС по слияниям поощрял национальных регуляторов запрашивать проверку сделок, которые не превышали пороговые значения продаж для расследований ЕС. Теперь такие проверки возможны лишь если национальные контролирующие органы уже открывали собственное расследование. Минторг США заставило Nvidia тщательнее следить за ускорителями, которые почему-то попадают в Китай
20.12.2024 [07:02],
Алексей Разин
Власти США пытаются различными способами ограничить доступ китайских компаний к передовым ускорителям вычислений американского происхождения, но иногда у них возникают и вопросы непосредственно к производителям оборудования. По данным The Information, сейчас Министерство торговли США попросило Nvidia проанализировать, как её продукция на протяжении текущего года попадала в Китай в условиях санкций. 
Источник изображения: Nvidia В свою очередь, Nvidia обратилась к крупным поставщикам типа Super Micro Computer и Dell Technologies с целью провести выборочную проверку своих клиентов в Юго-Восточной Азии на предмет соблюдения ограничений на поставку серверов с ускорителями Nvidia определённой номенклатуры в КНР. Пять источников, задействованных в поставках ускорителей Nvidia в Китай в обход санкций, сообщили The Information, что им до сих пор удавалось избежать раскрытия подобных операций. Представители Nvidia на подобную публикацию ответили следующим образом: «Мы настаиваем, что все наши клиенты и партнёры строго подчиняются ограничениям в сфере экспорта. Любое несанкционированное отклонение от них в части бывших в употреблении изделий, включая перепродажи на так называемом сером рынке, стало бы проблемой для нашего бизнеса, а не источником выгоды». Знакомые с ходом расследования представители Super Micro предположили, что покупатели могли подменить серийные номера серверного оборудования, используя значения, закреплённые за системами, эксплуатируемыми за пределами Китая. В некоторых случаях серийный номер подменялся на уровне операционной системы, что дополнительно затрудняло выявление «контрабанды». Представители Dell заявили, что требуют от клиентов выполнения всех законных требований и правил. Если партнёр компании не следует этому принципу, то контракт с ним может быть разорван. Super Micro также требует от всех своих партнёров соблюдения правил экспортного контроля США. По оценкам Omdia, в текущем году в тройку крупнейших покупателей ускорителей Nvidia семейства Hopper вошли сразу две китайские компании, хотя лидером с большим отрывом осталась Microsoft. Nvidia помогла Apple повысить эффективность больших языковых моделей ИИ
19.12.2024 [14:14],
Павел Котов
Инженеры Apple рассказали о сотрудничестве с Nvidia, благодаря которому им удалось повысить производительность систем при генерации текста большими языковыми моделями искусственного интеллекта. 
Источник изображения: developer.nvidia.com В этом году Apple опубликовала исходный код своего решения Recurrent Drafter (ReDrafter) — это новый метод генерации текста с помощью больших языковых моделей. Он отличается высокой скоростью работы, объединяя две технологии: лучевой поиск и динамическое древо внимания. Исследовательский проект Apple показал убедительные результаты, но при развёртывании ReDrafter технология была интегрирована в систему Nvidia TensorRT-LLM — этот инструмент позволяет быстрее запускать большие языковые модели на ускорителях Nvidia. Как показали замеры производительности, при запуске больших языковых моделей с десятками миллиардов параметров с использованием фреймворка Nvidia TensorRT-LLM и ReDrafter скорость генерации токенов увеличилась в 2,7 раза. Таким образом, технология позволяет сократить задержку между вводом запроса пользователем и получением ответа от модели — при этом используется меньшее число ускорителей и снижается потребление энергии, сделали вывод инженеры Apple. «Большие языковые модели всё чаще используются в работе приложений, и повышение эффективности вывода может повлиять на вычислительные издержки и сократить задержку для пользователей. Благодаря новому подходу ReDrafter к интегрированному во фреймворк Nvidia TensorRT-LLM спекулятивному выполнению разработчики теперь могут быстрее генерировать токены на ускорителях Nvidia для своих приложений», — добавили в Apple. Micron начала поставлять передовую память HBM3E не только Nvidia
19.12.2024 [13:40],
Алексей Разин
Около половины рынка микросхем памяти HBM сейчас контролирует южнокорейская SK hynix. В конце февраля текущего года Micron Technology заявила, что со второго квартала начнёт поставлять 8-ярусные стеки HBM3E для нужд Nvidia, которая будет устанавливать их в ускорители H200. На этой неделе стало известно, что подобную память Micron начала поставлять и загадочному второму крупному клиенту. 
Источник изображения: Micron Technology Под этим размытым определением может скрываться AMD, которая также оснащает свои ускорители вычислений семейства Instinct памятью типа HBM3E, но говорить об однозначном соответствии нельзя. Более того, на квартальной отчётной конференции на этой неделе руководство Micron Technology заявило, что в первом квартале следующего года компания начнёт снабжать своими микросхемами памяти семейства HBM третьего крупного клиента. В сентябре текущего года Micron представила 12-ярусные стеки HBM3E, тем самым продемонстрировав устранение отставания от SK hynix. Третий игрок этого рынка, южнокорейская компания Samsung Electronics, уже не первый месяц подряд пытается сертифицировать свою память типа HBM3E под нужды Nvidia, но раз за разом терпит неудачу, несмотря на регулярные заверения в близости успеха. На квартальной конференции руководство Micron подчеркнуло, что её 12-ярусной памятью HBM3E клиенты весьма довольны. Ёмкость рынка микросхем типа HBM компания Micron в привязке к 2025 году оценивает более чем в $30 млрд против ранее упоминавшихся $25 млрд. К 2028 году ёмкость рынка вырастет до $64 млрд, а по итогам 2030 года превысит $100 млрд. В текущем году данная величина не превысит $16 млрд, как считают в Micron. Что характерно, все заказы на производство HBM на следующий год у компании уже распределены, а цены зафиксированы в контрактах. В битве бигтехов за дефицитные чипы Nvidia победила Microsoft — она купила 485 тыс. ускорителей Hopper за год
18.12.2024 [13:07],
Алексей Разин
Исследования компании Omdia позволяют оценить, в каких количествах крупные клиенты Nvidia закупали в этом году ускорители вычислений. Поскольку серийно пока выпускаются только ускорители поколения Hopper, речь пойдёт именно о них, без учёта будущих Blackwell. Корпорация Microsoft оказалась крупнейшим покупателем ускорителей Hopper. 
Источник изображения: Nvidia По данным источника, на которые ссылается Financial Times, в этом году компанией Microsoft были куплены 485 000 ускорителей Nvidia поколения Hopper. Ближайшая американская компания, которой удалось приблизиться к Microsoft — это Meta✴✴ Platforms, но её 224 000 ускорителей Hopper более чем в два раза отстают от результата Microsoft. Последняя увеличила закупки ускорителей Nvidia Hopper более чем в три раза по сравнению с прошлым годом. Примечательно, что на втором и третьем местах в мировом рейтинге крупнейших клиентов Nvidia оказались китайские ByteDance и Tencent, которым даже в условиях американских санкций удалось заказать примерно по 230 000 ускорителей вычислений поколения Hopper, включая модифицированные с учётом экспортных ограничений H20. Точная цена чипов Hopper неизвестна, но принято считать, что один ускоритель Nvidia H100 стоит около $30 тыс. Таким образом Microsoft могла потратить по меньшей мере $14,5 млрд только на сами ускорители Nvidia. Это больше годового бюджета многих стран, например, бюджет Беларуси на 2024 год составил около $13,2 млрд. Microsoft при таких масштабах закупок может создавать передовую вычислительную инфраструктуру не только для себя, но и клиентов. OpenAI, получающая от Microsoft всемерную поддержку, использовала для обучения своей передовой модели o1 облачную инфраструктуру Microsoft Azure. На пятом месте среди крупнейших покупателей ускорителей вычислений Nvidia оказались принадлежащие Илону Маску (Elon Musk) компании Tesla и xAI, они приобрели около 200 000 ускорителей Hopper. На шестом месте оказался Amazon с 196 000 ускорителей, на седьмом Google с 169 000 ускорителями Nvidia. Стоит напомнить, что Amazon, Google и Meta✴✴ разрабатывают и собственные ускорители вычислений, включая специализированные процессоры. Google и Meta✴✴ в собственных системах в текущем году установили примерно по 1,5 млн таких процессоров. Amazon от них немного отстала с 1,3 млн собственных чипов. Microsoft с этой точки зрения сильнее зависит от Nvidia, поскольку собственных процессоров семейства Maia компания в текущем году установила не более 200 000 штук. Продукция AMD на этом фоне не так популярна, но Meta✴✴ в текущем году закупила 173 000 ускорителей Instinct MI300, а Microsoft приобрела около 96 000 штук. В общей сложности, компании технологического сектора в этом году на строительство своей серверной инфраструктуры потратили сообща $229 млрд, около 60 % всех инвестиций были распределены между десятью крупнейшими игроками рынка. Nvidia досталось около 43 % средств компаний, направленных на развитие своей вычислительной серверной инфраструктуры. Скорее всего, для неё это значение окажется пиковым, поскольку конкуренция на рынке ускорителей вычислений не стоит на месте. Nvidia представила крошечный ИИ-компьютер Jetson Orin Nano Super всего за $249 для создания умных роботов и дронов
17.12.2024 [19:10],
Сергей Сурабекянц
Компания Nvidia представила одноплатный компьютер Jetson Orin Nano Super для разработчиков различных систем с искусственным интеллектом, включая дронов, роботов и т.д. Новинка обеспечивает на 70 % большую производительность по сравнению с Jetson Orin Nano и стоит вдвое дешевле. Производительность Jetson Orin Nano Super — 67 TOPS при цене $249, что является серьёзным улучшением по сравнению с 40 TOPS у предшественника стоимостью $499. 
Источник изображений: Nvidia Jetson Orin Nano Super оснащён шестиядерным процессором Arm Cortex-A78AE, работающим на частоте 1,7 ГГц, и поставляется с 8 Гбайт оперативной памяти. Графический процессор с частотой 1020 МГц имеет 1024 ядра CUDA и 32 тензорных ядра, что обеспечивает максимальную производительность в 67 TOPS. Система может питаться либо через порт USB Type-C, либо через проприетарный разъём, в любом случае для максимальной производительности мощность источника питания должна составлять не менее 25 Вт. Плата оборудована четырьмя портами USB 3.2 Type-A, которые работают на скорости 10 Гбит/с, двумя портами MIPI CSI, совместимыми с камерой Raspberry Pi и разъёмами M.2 2280 и M.2 2230 для подключения SSD. Jetson Orin Nano Super также оборудован 40-контактным разъёмом GPIO, совместимым с Raspberry Pi, что предполагает возможность использования плат расширения Raspberry Pi Hats. Jetson Orin Nano Super работает под управлением специализированной версии Linux — L4T, созданной специально для работы на оборудовании Nvidia. Загрузка системы может осуществляться как с SSD, так и с карты памяти формата microSD. По данным Nvidia, Jetson Orin Nano Super демонстрирует прирост производительности относительно оригинального Jetson Orin Nano в обучении больших языковых моделях на 37–63 %, задачах машинного зрения — на 36–104 %, и в распознавании изображений — на 43–69 %. Nvidia отметила, что другие её одноплатные компьютеры текущего поколения, включая «обычный» Jetson Orin Nano, также получат прирост производительности до 70 процентов после обновления программного обеспечения. Например, производительность Orin NX 16 Гбайт увеличится со 100 до 157 TOPS, а Orin NX 8 Гбайт — с 70 до 117 TOPS. Одноплатный компьютер Nvidia Jetson Orin Nano Super появится в продаже в конце этого месяца. Acer раскрыла, сколько видеокарты GeForce RTX 5090 и RTX 5080 получат памяти GDDR7
17.12.2024 [18:33],
Николай Хижняк
Acer была одной из первых компаний, кто стал рекламировать новые процессоры Intel Core Ultra 200S в составе своих игровых систем Predator Orion 7000 в сентябре этого года, за два месяца до их официального анонса. Сейчас аналогичная ситуация наблюдается с видеокартами GeForce RTX 5000. Acer объявила, что её игровые ПК получат ускорители Nvidia GeForce RTX 5090 и RTX 5080. Более того, производитель сообщил одну из ключевых характеристик этих видеокарт — объём видеопамяти. 
Источник изображений: VideoCardz В Сети давно ходят слухи относительно объёма памяти новых видеокарт GeForce RTX 50-й серии. Согласно этим данным, флагманская модель RTX 5090 получит 32 Гбайт памяти нового поколения GDDR7, а видеокарта RTX 5080 — только половину этого объёма. Acer в своих рекламных материалах для игровых систем Predator Orion 7000 подтверждает эту информацию. Примечательно, что эту информацию ранее также косвенно производила компания Zotac, выпускающая видеокарты GeForce. На своём сайте она создала несколько разделов для новых моделей ускорителей.  Информация об объёме памяти видеокарт GeForce RTX 50-й серии также благодаря Zotac теперь отображается в поиске Google. Согласно последним слухам, модель RTX 5080 получит графический процессор GB203-400 с 10 752 ядрами CUDA и 16 Гбайт памяти GDDR7 с поддержкой 256-битной шины. Энергопотребление видеокарты прогнозируется на уровне 400 Вт. В свою очередь, модель RTX 5090 должна получить графический чип GB202-300 с 21 760 ядрами CUDA и 32 Гбайт памяти GDDR7. А её заявленный показатель энергопотребления будет ниже 600 Вт. 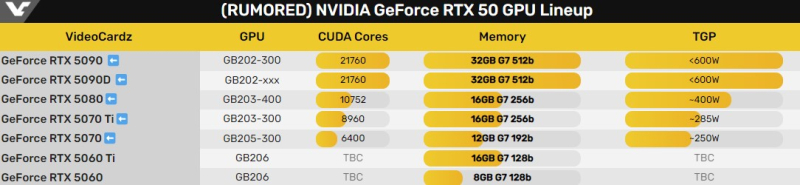
Ожидаемые модели видеокарт GeForce RTX 50-й серии и их характеристики. Источник изображения: VideoCardz Анонс игровых видеокарт Nvidia нового поколения Blackwell ожидается на выставке CES 2025 в первых числах января. Nvidia готовится провести мероприятие GeForce 50 LAN по завершении которого, как прогнозируется, будут представлены новые видеокарты. Инвесторы разуверились в Nvidia и бросились скупать акции Broadcom
17.12.2024 [15:47],
Павел Котов
За последние пять дней акции Nvidia потеряли в цене 5 %, в то время как акции Broadcom напротив набрали впечатляющие 40 %. В обоих случаях на динамику курсов влияет ажиотаж вокруг искусственного интеллекта, обращает внимание CNBC. 
Источник изображения: broadcom.com Акции Nvidia сегодня перед началом торгов показали снижение на 1,8 % и вошли в зону коррекции — так называется граница, обозначающая падение цены на 10 % или более от исторического максимума при закрытии. Исторического максимума на закрытии торгов акции Nvidia достигли в ноябре на отметке $148,88. В то же время ценные бумаги Broadcom продолжили рост и до начала торгов подорожали на 1,9 %. Оптимизм инвесторов вокруг Broadcom спровоцировал опубликованный компанией квартальный отчёт: выше ожидаемых оказались величина прибыли и собственный прогноз выручки чипмейкера. Ценовые ориентиры на акции Broadcom повысили несколько крупных брокеров с Уолл-стрит, в том числе Goldman Sachs. Впрочем, резких перемен в расстановке сил пока не ожидается: с начала года акции Broadcom прибавили в цене 120 %, а ценные бумаги Nvidia за то же время подорожали на 160 %. Ускорители искусственного интеллекта Nvidia применяются при обучении крупнейших моделей большинством разработчиков; Broadcom разрабатывает интерфейсы, которые позволяют создавать более сложные ИИ-ускорители, а также создаёт сетевые интерфейсы, которые необходимы для крупнейших провайдеров облачных услуг. Nvidia App уличили в замедлении видеокарт — Nvidia рассказала, как это исправить
17.12.2024 [11:40],
Владимир Фетисов
В прошлом месяце Nvidia выпустила обновлённый пакет драйверов для своих графических ускорителей. Вместе с ним вышло приложение Nvidia App, которое стало заменой признанному устаревшим GeForce Experience. Теперь же стало известно, что новое приложение Nvidia может снижать производительность системы в играх, причём в некоторых случаях теряется до 15 % производительности. 
Источник изображения: Nvidia Пользователям предлагается установить Nvidia App при первом запуске GeForce Experience после загрузки пакета драйверов версии GeForce Game Ready Driver 566.14, распространение которого началось в прошлом месяце. Можно отказаться от загрузки этого ПО, но важно понимать, что в дальнейшем новые версии GeForce Experience выходить не будут. С выходом пакета драйверов версии 566.36 компания Nvidia полностью избавилась от GeForce Experience, оставив только Nvidia App. Поэтому пользователям придётся установить это приложение или же отказаться от использования дополнительных функций, которые оно предлагает, устанавливая только драйверы. Похоже, что на данном этапе отказ от использования Nvidia App может стать оптимальным решением, поскольку это ПО снижает производительность в играх, причём в некоторых случаях весьма ощутимо. В ходе тестов с ускорителем GeForce RTX 4060 портал Tom's Hardware зафиксировал падение кадровой частоты от 2 % до 12 % в пяти играх. 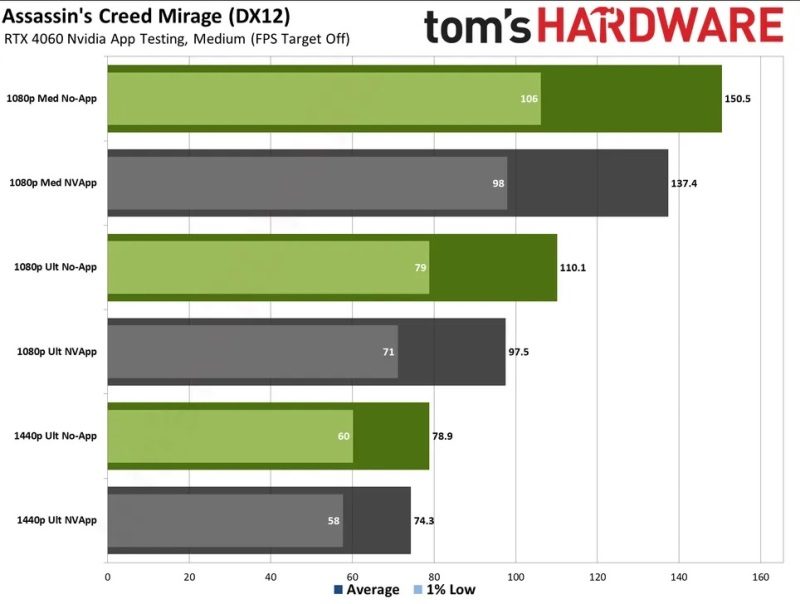
Источник изображения: tomshardware.com Отмечается, что в некоторых случаях использование Nvidia App дало положительный результат. Например, в Stalker 2 и Microsoft Flight Simulator 2024 было небольшое повышение производительности, но в пределах погрешности. В остальных случаях отсутствие Nvidia App способствовало повышению производительности в играх. Ожидалось, что наиболее заметно это будет при использовании средних настроек и разрешения 1080p, но оказалось, что падение производительности в основном не зависит от выбранного разрешения. Хотя тестирование проходило с использованием одной видеокарты, очевидно, что существует проблема снижения производительности при использовании Nvidia App. По некоторым данным, больше всего пострадали игры на базе движка Unreal Engine 5. По данным источника, хуже всего ситуация обстоит в Assassin’s Creed Mirage, где показатели упали на 9 % при разрешении 1080p и средних настройках качества, на 12 % при разрешении 1080p и максимальных настройках и на 6 % при разрешении 1440p и максимальных настройках. В Stalker 2 показатели снизились почти на 6 %, а в Black Myth: Wukong — на 2-6 %. Baldur’s Gate 3 с DirectX 11 потеряла 3-4 % производительности, а Flight Simulator 2024 — 6 % при использовании разрешения 1080p. 
Источник изображения: tomshardware.com Можно с уверенностью сказать, что потеря производительности будет варьироваться в зависимости от разных процессоров и видеокарт, которые установлены в ПК пользователей. Один из пользователей сообщил о снижении производительности на 15 % в Black Myth: Wukong при тестировании с процессором AMD Ryzen 7 9800X3D и видеокартой GeForce RTX 4080 Super. Может оказаться, что более производительные ускорители больше пострадают от этой проблемы. Официальные представители Nvidia пока никак не комментируют данный вопрос. Ожидается, что они детально изучат проблему, чтобы постараться её исправить. Пока этого не случилось, пользователям, возможно, стоит отказаться от установки Nvidia App, ограничиваясь загрузкой пакета драйверов. Обновлено: Компания Nvidia подтвердила, что её приложение может снижать FPS и пообещала исправить это с будущим обновлением. Также компания рассказала, как исправить положение уже сейчас: «Мы знаем о проблеме с производительностью, связанной с игровыми фильтрами, и активно изучаем ее. Вы можете отключить "Игровые фильтры" (Games Filters) в настройках Nvidia App, перейдя в "Функции" –> "Оверлей" –> "Игровые фильтры и Фоторежим" (Features –> Overlay –> Game Filters and Photo Mode), а затем перезапустить игру». TSMC к 2026 году утроит мощности по упаковке чипов методом CoWoS, чтобы лучше обслуживать Nvidia
15.12.2024 [08:19],
Алексей Разин
Бурный рост выручки Nvidia на фоне высокого спроса на её ускорители вычислений в действительности сдерживается возможностями её производственных партнёров, главным из которых является TSMC. Последняя не только выпускает чипы для Nvidia, но и упаковывает их передовым методом CoWoS, и возможности подрядчика в этой сфере являются для Nvidia узким местом, которое он готов активно расширять. 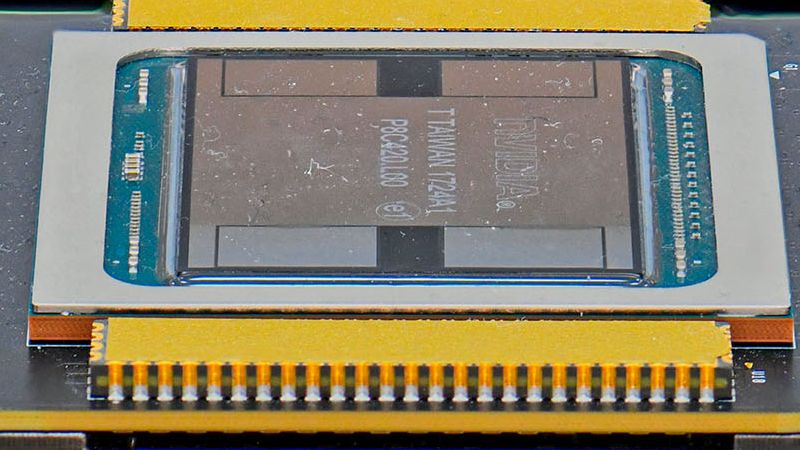
Источник изображения: TSMC По информации Commercial Times, компания TSMC интенсивно расширяет на территории Тайваня свои производственные мощности по тестированию и упаковке чипов методом CoWoS. Купленное у Innolux предприятие по производству ЖК-панелей в Тайнане будет переоборудовано под тестирование и упаковку чипов к концу следующего года, и совокупные возможности TSMC в этой сфере к концу 2026 года утроятся до 90 000 кремниевых пластин в месяц, по данным тайваньских источников. Профильное предприятие TSMC в Тайчжуне будет введено в строй в первой половине следующего года, компания также строит два предприятия в других районах острова. В текущем году, по оценкам аналитиков, TSMC была способна упаковывать и тестировать чипы с использованием метода CoWoS в количестве, эквивалентном 35 000 кремниевых пластин в месяц. Выручка от данного вида услуг достигла 7–9 % от совокупной. К концу следующего года мощности удвоятся до 70 000 пластин в месяц, а доля выручки перевалит за 10 %. Наконец, к концу 2026 года TSMC сможет ежемесячно упаковывать по методу CoWoS количество чипов, эквивалентное 90 000 кремниевых пластин. Итого, с 2022 по 2026 годы производительность компании в этой сфере будет увеличиваться ежегодно в среднем на 50 %, причём процесс продолжится и после 2026 года. Одно только предприятие в Тайнане теоретически могло бы ежемесячно обрабатывать по 50 000 кремниевых пластин в месяц. Скорее всего, профильными заказами оно в итоге будет загружено только частично, а остальные мощности выделят под работу с методами упаковки CPO и FoPLP. Nvidia закатит в честь анонса видеокарт GeForce RTX 5000 геймерскую вечеринку на 50 часов
13.12.2024 [12:01],
Алексей Разин
Программа присутствия Nvidia на ежегодной отраслевой выставке электроники CES в Лас-Вегасе, как минимум, предусматривает выступление главы и основателя компании Дженсена Хуанга (Jensen Huang), но ближе к началу мероприятия стали известны и другие подробности запланированной активности. Производитель видеокарт проведёт для геймеров 50-часовую вечеринку впервые за почти полтора десятка лет. 
Источник изображения: Nvidia Как отмечает ресурс ComputerBase.de, последнее классическое мероприятие такого плана проходило в 2011 году на борту американского авианосца USS Hornet, оно носило обозначение GeForce LAN 6 и посвящалось любителям компьютерных игр. Новое мероприятие, запланированное Nvidia на первую неделю января, носит символическое обозначение «GeForce LAN 50», поскольку число в его наименовании может иметь отношение к новому семейству видеокарт GeForce RTX 50, чей анонс ожидается в начале января. Кроме того, число 50 соответствует и запланированной продолжительности этой геймерской вечеринки, которая рассчитана на 50 часов активности. К половине пятого вечера 4 января по местному времени в Лас-Вегасе должна стартовать GeForce LAN 50, а завершится она уже 6 января в половину седьмого вечера. К тому моменту на сцене CES 2025 должен появиться генеральный директор и президент Nvidia Дженсен Хуанг со своим традиционным докладом, по итогам которого должна быть представлена новая серия видеокарт этой марки. К слову, синхронные вечеринки для геймеров пройдут также в Берлине, Пекине и Тайбэе, поэтому принять в них участие смогут не только жители США. Учитывая организацию онлайн-трансляций, сопереживать участникам сможет гораздо более широкий круг наблюдателей. Кроме того, Nvidia подготовила подарки для тех, кто не может приехать. Тем, кто будет играть в Diablo IV, The Elder Scrolls Online, Fallout 76, The Finals или WoW через облачный сервис GeForce Now «непрерывно в течение 50 минут», будет выдано какое-то внутриигровое вознаграждение. Nvidia также будет предлагать призы в рамках маркетинговой акции, которую она называет GeForce Greats. Nvidia придумала, чем будет покорять Китай вместо передовых ИИ-ускорителей
12.12.2024 [12:11],
Алексей Разин
В третьем квартале китайский рынок полупроводниковых компонентов в целом хоть и не стал крупнейшим для Nvidia, всё равно принёс компании солидные $5,4 млрд выручки. Лишившись права активно продавать китайским клиентам свои передовые ускорители вычислений, Nvidia делает ставку на развитие китайского автомобильного рынка, расширяя локальный штат разработчиков соответствующего профиля. 
Источник изображения: Nvidia В частности, как отмечает Bloomberg, если общая численность персонала Nvidia в Китае по итогам текущего года вырастет на треть с 3000 до 4000 человек, то около 200 новых специалистов получат работу в пекинском исследовательском центре, который сосредоточится на разработке систем активной помощи водителю. Штат китайских сотрудников Nvidia также расширен за счёт специалистов по послепродажному обслуживанию и разработке программного обеспечения для сетевых решений. Компонентами и программным обеспечением Nvidia на крупнейшем в мире автомобильном рынке пользуются многие производители транспортных средств, начиная с лидера китайского рынка BYD и холдингом Geely, которому принадлежат марки Volvo, Polestar, Zeekr, Lynk & Co и Lotus, и заканчивая стартапами по производству электромобилей типа Nio и XPeng. Очевидно, им нужна поддержка со стороны поставщика аппаратных компонентов и связанного ПО, это и вынуждает Nvidia расширять штат своих специалистов в Китае. По состоянию на февраль текущего года Nvidia располагала 29 600 сотрудниками в 36 странах мира. Китай со своими 4000 сотрудников Nvidia в последние годы демонстрировал устойчивую динамику расширения штата, в ориентированном на автомобильный рынок пекинском офисе компании сейчас трудится около 600 человек. В местном технопарке Чжунгуаньцунь компания Nvidia также недавно открыла новый офис. |
|
✴ Входит в перечень общественных объединений и религиозных организаций, в отношении которых судом принято вступившее в законную силу решение о ликвидации или запрете деятельности по основаниям, предусмотренным Федеральным законом от 25.07.2002 № 114-ФЗ «О противодействии экстремистской деятельности»; |