Samsung Electronics обеспечит компании NVIDIA поставку высокопроизводительных полупроводниковых компонентов и услуги по упаковке чипов. Сотрудничество с таким партнёром поможет корейскому электронному гиганту обеспечить себя заказами и от других технологических компаний.

Источник изображений: semiconductor.samsung.com
Samsung и NVIDIA сейчас проводят технологическую проверку стеков памяти HBM3 (High Bandwidth Memory) от Samsung, а также качества услуг по упаковке чипов для графических процессоров американской компании, сообщает Korea Economic Daily со ссылкой на собственный источник из Сеула. По завершении работ Samsung будет осуществлять упаковку чипов H100, составляющих основу ускорителей NVIDIA для систем искусственного интеллекта, а также станет поставщиком стеков памяти HBM3 для этих ускорителей. Соглашение будет заключено в конце года.
Упаковка — один из последних этапов производства полупроводников. Она предполагает размещение микросхемы на подложке из текстолита со всеми контактами и интерфейсами, необходимыми для работы чипа и его подключения к другим компонентам системы. NVIDIA традиционно полагалась на TSMC, которая производит упаковку чипов с использованием собственной технологии; память HBM3 для ускорителей выпускала SK hynix. Но в связи с высоким спросом на компоненты для ИИ, а также загруженностью линий TSMC американский производитель был вынужден искать альтернативное предложение, которое ей обеспечила Samsung. В рамках нового партнёрства корейская компания может получить заказ и на производство самих графических процессоров NVIDIA, но пока речь только о поставках памяти и упаковке чипов. Все больше технологических компаний могут начать обращаться в Samsung в связи с загруженностью упаковочных линий TSMC, утверждает источник издания.
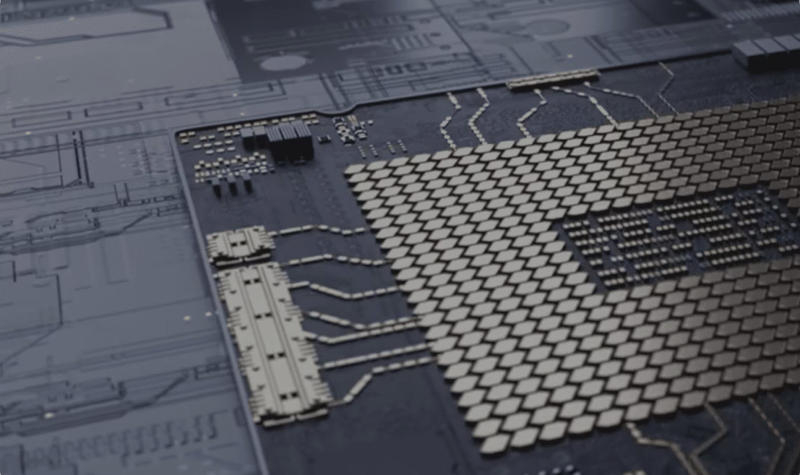
Крупнейшие мировые полупроводниковые подрядчики в лице Samsung, TSMC и Intel жёстко конкурируют на рынке передовых технологий упаковки, позволяющих объединять разнородные компоненты или вертикально соединять несколько микросхем. В 2021 году мировой рынок этого сегмента составлял $37,4 млрд, а к 2027 году он может вырасти на 74 % до $65 млрд. Сегодня отрасль сосредоточен на технологии 2.5D, предполагающей симбиоз графических процессоров и памяти HBM, которая в 10 раз быстрее DRAM. Мировым лидером является TSMC, которая вот уже шесть лет работает над технологией 2.5D — недавно компания сообщила, что планирует инвестировать 90 млрд тайваньских долларов ($2,9 млрд) в новый завод по производству упаковки на Тайване. В 2021 году компания представила технологию 2.5D I-Cube: во II квартале 2024 года стартует массовое производство компонентов I-Cube4 с графическим процессором и четырьмя чипами HBM, а в III квартале настанет черёд I-Cube8 с восемью чипами HBM.
Samsung же стремится сделать своей сильной стороной предложение упаковки «под ключ», способное привлечь крупные технологические компании. Корейский производитель начал оказывать услугу, охватывающую весь процесс выпуска полупроводников: поставки чипов памяти, упаковку и тестирование — это поможет компании стать привлекательной альтернативой TSMC в условиях интенсивного роста отрасли ИИ. Спрос на услугу «под ключ» будет расти, помогая клиентам экономить время и деньги, а не привлекать подрядчиков для каждой услуги.
Кроме того, Samsung и её местный конкурент SK hynix планируют значительно расширить линии производства памяти типа HBM — к концу 2024 года они планируют вложить в это направление более 2 трлн вон ($1,56 млрд), что поможет более чем вдвое увеличить производственную мощность линий HBM. Пока рынок DRAM пытается выйти из пике, спрос на HBM продолжает демонстрировать положительную динамику: в 2022 году он был 181 млн Гбайт; в 2023 году может подскочить на 60 % до 290 млн Гбайт, а в 2024 году может вырасти ещё на 30 % в годовом исчислении, подсчитали аналитики TrendForce.
Источники:


 MWC 2018
MWC 2018 2018
2018 Computex
Computex
 IFA 2018
IFA 2018






