Компания Samsung объявила о планах предложить клиентам своего контрактного производства чипов передовую технологию пространственной компоновки. Проще говоря, Samsung сможет выпускать чипы, состоящие из нескольких кристаллов, уложенных один на другой. Это позволит Samsung лучше конкурировать с крупнейшим контрактным производителем чипов — TSMC.

Источник изображения: Kedglobal.com
Как сообщает The Korea Economic Daily, на недавно прошедшем форуме Samsung Foundry в Сан-Хосе компания анонсировала запуск услуги по 3D-упаковке с применением стеков HBM (High Bandwidth Memory). В настоящее время память HBM в основном использует 2.5D-технологию, то есть размещается в непосредственной близости от микросхемы GPU или другого чипа на общей кремниевой подложке. Однако Samsung готова устанавливать стеки HBM непосредственно на кристаллы процессоров. Это обеспечит ещё более высокую скорость передачи данных и уменьшит задержки, поскольку позволит отказаться от пересылки данных через подложку.
Ожидается, что 3D-упаковка появится на рынке для HBM четвёртого поколения, которое также называют HBM4. Данная память начнёт активно применяться в 2025–2026 годах. Интересно, что анонс Samsung последовал после презентации генерального директора NVIDIA Дженсена Хуанга (Jensen Huang) на выставке Computex 2024, где он представил Rubin — архитектуру ускорителей вычислений следующего поколения, которая как раз будет использовать памяти HBM4.
Samsung планирует предлагать 3D-упаковку с HBM4 «под ключ», то есть интегрировать на чипы стеки памяти собственного производства. Отдел Samsung, отвечающий за передовую упаковку, будет устанавливать стеки HBM, произведенные в подразделении Samsung по выпуску памяти, с графическими процессорами, изготовленными подразделением контрактного производства.
Компания называет свою новую технологию упаковки SAINT-D, сокращенно от Samsung Advanced Interconnection Technology-D. «3D-упаковка снижает энергопотребление и задержку обработки, улучшая качество электрических сигналов полупроводниковых чипов», — заявил представитель Samsung Electronics. Услуги по 3D-упаковке HBM4 «под ключ» планируется запустить в 2027 году.
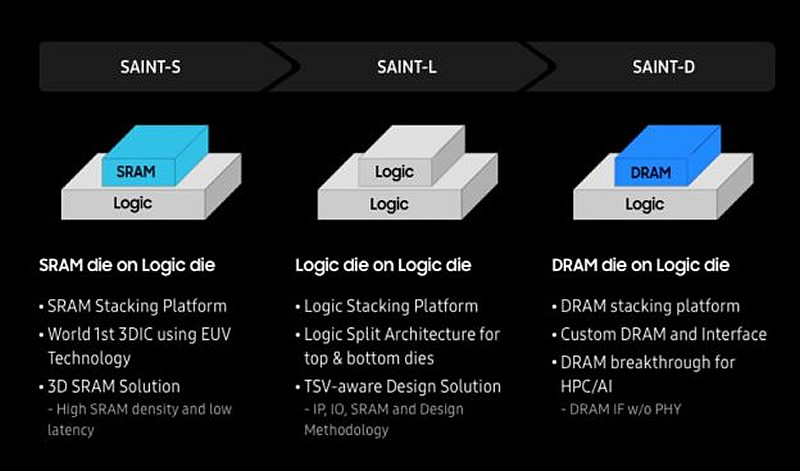
Источник изображения: Trendforce.com
В связи с растущим спросом на высокопроизводительные чипы HBM, по прогнозам, в 2025 году на память данного типа придётся 30 % от всего рынка DRAM в следующем году против 21 % в 2024 году.
Источники:


 MWC 2018
MWC 2018 2018
2018 Computex
Computex
 IFA 2018
IFA 2018