⇣ Содержание

|
Опрос
|
реклама
Самое интересное в новостях
Разрубить EUV-узел
Фотолитограф на базе источника экстремального ультрафиолетового излучения (EUV), оптическая система которого характеризуется высокой числовой апертурой (High-NA; характерное значение этой самой апертуры здесь — 0,55 против 0,33 у прежних EUV-машин), — удовольствие недешёвое: около 400 млн долл. США за штучку. Да, с помощью такой машины формировать на пластинах-заготовках микросхемы по «3-нм», «2-нм» и ещё более миниатюрным техпроцессам проще, чем на EUV-агрегатах предыдущего поколения, с более скромной числовой апертурой. Однако разница в цене настолько велика (порядка 50 млн долл.), что самый успешный чипмейкер планеты, тайваньская TSMC, пока не спешит даже точно определяться со сроками приобретения у голландской ASML — единственного на весь мир поставщика таких установок — своего первого High-NA-фотолитографа, обходясь до сих пор — даже на уровне «2 нм» — доналадкой более ранних EUV-литографов. И это вовсе не из соображений «От добра добра не ищут», а по чисто материальной причине: слишком уж дорого. Если учесть, что нынешние геополитические реалии — запрет Минторга США на поставки в КНР как самогó такого рода оборудования, так и выполненных на нём наиболее передовых микросхем — драматически сужают потенциальный рынок сбыта того и других, сроки окупаемости новейших фотолитографов растягиваются для изготовителей чипов и вовсе до каких-то неприличных масштабов. Прибавим сюда всё никак не желающую идти на поправку глобальную экономику: непривычно (для последнего примерно полувека) высокие ставки рефинансирования мировых центробанков, начиная с американской ФРС, делают долгосрочные крупные инвестиции откровенно невыгодными для коммерсантов в любой точке планеты. 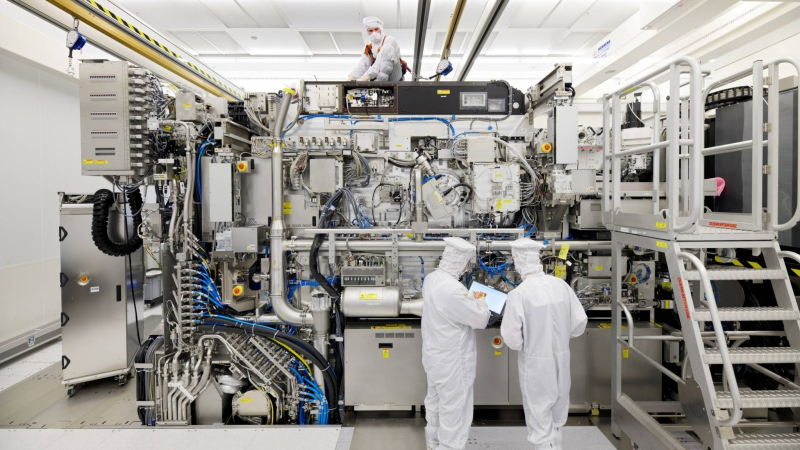
За исключением голландской ASML, никто в мире не способен сегодня изготавливать не только High-NA-, но и серийные EUV-фотолитографы «попроще» (источник: ASML) В то же время достаточно очевидно, что, если ажиотаж вокруг искусственного интеллекта сохранится хотя бы в среднесрочной перспективе (3-5 лет), более плотно набитые, чем сегодня, транзисторами чипы изготавливать всё-таки придётся, иначе не выйдет адекватно справляться со стремительным ростом числа параметров генеративных моделей ближайшего будущего; об этом мы упоминали в недавнем материале «Задача на триллион». Неудивительно, что High-NA EUV как откровенно экстенсивной ветке развития чипмейкерских технологий активно ищут замену, притом по обе стороны Тихого океана. И в КНР, волюнтаристски отрезанной от этого направления микропроцессорного прогресса, поиски ведут едва ли не усерднее, чем в США, что задыхаются от неуклонного взлёта расходов на фоне всё более заметного разочарования инвесторов в долларе (и номинированных в нём ценных бумагах) как в разумном средстве средне- и долгосрочного сбережения капитала. ⇡#При всём богатстве выбора…Чуть больше года назад мы уже делали обзор технологий, в принципе способных соперничать с фотолитографами High-NA EUV, что полагаются в качестве источника света на LPP (laser-produced plasma — плазму, создаваемую лазерными импульсами, которые испаряют капли расплавленного сверхчистого олова). Перечень таких технологий довольно узок: это аналогичная по оптической схеме установка, но с лазером на свободных электронах (FEL EUV), во многом схожая с ней «литографическая пушка» на базе ускорителя со стационарным микрогруппированием электронов (SSMB EUV), безмасочный литограф на высокоэнергетических фотонах, ионно-лучевой и, наконец, наноимпринтный фотолитографы. Каждый из этих подходов — по крайней мере, так обещают их разработчики, — призван снять с повестки дня один, несколько или даже все разом недостатки LPP EUV: необходимость полагаться на отражательные, а не работающие на просвет фотомаски (что затрудняет, в частности, как контроль качества их изготовления, так и своевременное выявление оседающих на них даже в сверхчистом производственном помещении микрочастиц); чудовищно невысокий энергетический КПД (чтобы создать пучок фотонов условной мощностью 1 кВт, что направляется затем в оптическую систему, затрачивают до 4,4 МВт электроэнергии, а до поверхности пластины-заготовки добираются и вовсе единичные ватты), появление на поверхности получаемых микросхем стохастически обусловленных сбоев типа line break и micro-bridging и т. д. Кроме того, довольно изощрённый способ получения необходимой для работы EUV-фотолитографа длины волны — 13,5 нм — заметно усложняет узел генерации фотонного пучка: к примеру, микробрызги и отдельные частицы испаряемых лазерным лучом оловянных капелек приходится, чтобы они не оседали на элементах оптической системы, сдувать сильным потоком газообразного водорода, который расходуется в темпе 600 литров в минуту. Да, отработанный газ частично улавливают и после очистки используют повторно, но простоты и изящества, равно как и дешевизны, системе в целом всё это отнюдь не прибавляет. 
Лабораторный линейный ускоритель электронов безупречно формирует пучок когерентного, но пока что микроволнового излучения, и, хотя теоретических препятствий масштабировать его до испускания 13,5-нм фотонов нет, средств и времени это потребует немало (источник: KEK) У подхода FEL EUV, который на схемах и в презентациях выглядит, пожалуй, привлекательнее прочих соперников LPP, — своя немалая в самом прямом смысле сложность: конструкционный гигантизм. Японские исследователи из High Energy Accelerator Research Organization (традиционно принятая для этого учреждения аббревиатура происходит не от английского, а от записанного латиницей японского названия — KEK) уже не первый год успешно генерируют пучки высокоэнергичных электронов, которые заставляют затем, прогоняя через ондулятор, испускать фотоны строго определённой длины волны (с крайне низкой дисперсией, что для фотолитографии — огромный плюс), причём с КПД на уровне 1-10%, для LPP EUV в принципе недостижимым. И всё было бы замечательно — в чём уверен, кстати, и бывший гендиректор Intel Пэт Гелсингер (Pat Gelsinger), который в начале 2025-го стал председателем правления компании xLight, что независимо разрабатывает свой FEL-источник, совместимый с ныне актуальным фотолитографическим оборудованием, — если бы не одно но. А именно: по чисто физическим причинам лабораторная установка KEK, что практически целиком занимает зал 60×20 метров, формирует электронный пучок с энергией 17 МэВ (миллионов электронвольт), который, в свою очередь, порождает серию квантовых импульсов с длиной волны 20 мкм, — но это, увы, даже не самый ближний ИК-диапазон. Да, речь пока идёт только о прототипе, и после соответствующего масштабирования — с увеличением плеча генерации, энергии потока электронов, числа и плотности формирующих ондулятор магнитов — (теоретически) удастся создать по тому же самому принципу и вожделенный 13,5-нм FEL-источник EUV-фотонов. Исследователи уверены, что с этим справится в несколько раз укрупнённая по всем измерениям система, способная сформировать электронный пучок на 800 МэВ, — в 2021 г. стоимость изготовления такой оценивалась примерно в 260 млн долл. США, а ежегодные расходы на её содержание — ещё примерно в 25 млн долл. В сегодняшних ценах это наверняка окажется сопоставимо со стоимостью новенькой установки EUV, даже не High-NA, — однако, напомним, FEL-система всего лишь формирует пучок фотонов, который надо ещё направить на оптическую схему и далее на пластину-заготовку. Иными словами, полнофункциональный фотолитограф с источником излучения FEL EUV обойдётся, по грубым прикидкам, вдвое-втрое дороже самого современного нынешнего серийного аппарата под маркой ASML, не говоря уже о том, что будет представлять собой всего лишь первый опытный образец; и сколько займёт вывод его на готовность к поточному изготовлению микросхем — непонятно. И, самое главное, принципиально ничего нового покупателю он не даст — всего лишь заменит источник света; оптический же блок и узел размещения пластины-заготовки придётся оставлять прежними. А в современных макроэкономических реалиях, повторимся, навряд ли отыщется инвестор (даже на уровне не самого бедного государства), готовый вложить средства в чипмейкерскую технологию промышленного уровня, что обещает заменить лишь часть пусть дорогостоящей и несовершенной, но уже вполне отлаженной системы High-NA EUV. Самим США это просто невыгодно, — подавляющая доля патентов, на основании которых голландская ASML конструирует свои фотолитографы, принадлежат как раз американским разработчикам; почему, собственно, власти страны по ту сторону Атлантики и имеют формальное право указывать европейскому производителю, кому продавать его станки, а кому нет. КНР — дело другое; и, вполне возможно, именно в Поднебесной электронные пучки (есть даже шанс, что не от специально созданного с этой целью ускорителя, а от уже действующих научных систем такого рода — благо те уже построены и работают) впервые начнут применять для генерации EUV-излучения как раз с целью последующего литографирования серийных микросхем. В конце весны 2024 г. китайские власти, следуя намеченному ранее плану «Made in China 2025», проинвестировали через принадлежащие государству частично или полностью банки эквивалентную 47,5 млрд долл. сумму в развитие локальной полупроводниковой индустрии — точнее, в специализированный China Integrated Circuit Industry Investment Fund, выделяющий средства как раз на эти цели. Внушительная инвестиция стала уже третьей по счёту: первая, на 19,2 млрд долл., была сделана ещё в 2014-м; вторая, на 28,2 млрд долл., — в 2019-м. В итоге правительство КНР рассчитывает выйти на общемировой уровень полупроводниковых производств уже к 2030 г. 
Скупая (мягко говоря) на детали схема из патента №202110524685X показывает в самых общих чертах, как будет действовать предполагаемый EUV-фотолитограф от Huawei, — судя по этому рисунку, не намного отличным от работы машин ASML образом (источник: CNIPA) Собственно, ещё в 2022-м Huawei обнародовала свою патентную заявку за номером 202110524685X на оригинальный EUV-фотолитограф (точнее, фотолитографический сканер, или степпер, — мы уже обсуждали историю появления этих терминов, в настоящее время по сути полностью взаимозаменяемых) целиком, включая источник излучения, отражательную оптическую систему, собственно узел литографирования (где происходит экспонирование фоторезиста на заготовке и последующие химические процедуры с ним), а также необходимое для контроля всех перечисленных процессов метрологическое оборудование. Ясное дело, сам факт объявления о том, что некий процесс теоретически проработан в деталях и готов к воплощению на практике (именно в этом смысл патентования) вовсе не эквивалентен готовности немедленно приступать даже к сборке заявленного устройства, не говоря уже о его применении для изготовления реальных чипов. Однако примерно год спустя компания SMEE (Shanghai Micro Electronics Equipment), ведущий в материковом Китае изготовитель оборудования для полупроводниковых производств, зарегистрировала уже более предметный патент — на «Генератор экстремального ультрафиолетового излучения и соответствующее литографическое оборудование». Правда, здесь речь идёт о всё той же LPP, — судя по всему, в условиях усиливающегося давления со стороны США на поставщиков передовых технологий в КНР китайские разработчики решили не делать ставку на не освоенную никем прежде область, а постараться воспроизвести то, что уже с гарантией работает. И осуждать их за это трудно — не они такие, время такое. ⇡#Есть куда растиВпрочем, есть вероятность, что копировать один к одному EUV-литографы ASML (оставляя даже пока в стороне вопросы прав на интеллектуальную собственность и говоря о чисто технической стороне дела) китайским инженерам не придётся: по крайней мере, источник света и тракт движения фотонов в системе у него почти наверняка будут иными. Дело опять-таки не в том, что ASML ныне принадлежат все патенты на громоздкую и капризную конструкцию, внутри которой под разрядами углекислотного лазера превращаются в облачка плазмы оловянные микрокапли, а в патетически низкой, на что мы уже обращали внимание, эффективности такого процесса: он и требует жутко дорогого оборудования, и энергию потребляет в гаргантюанских объёмах, и обслуживание его влетает в копеечку. Синхротрон в этом плане не выглядит бесспорным шагом вперёд — он велик и дорог сам по себе. Хотя у него, оговоримся, есть и другие применения; никто не мешает один и тот же кольцевой ускоритель электронов использовать и для научных изысканий, и для формирования необходимых при изготовлении микросхем когерентных EUV-лучей, и для иных прикладных задач. Однако куда практичнее было бы всё-таки отыскать такой специализированный источник 13,5-нм излучения, который был бы компактнее и практичнее ныне доступных. И такие работы активно ведутся — в конце концов, разработчик актуального «света в окошке» EUV-фотолитографии, компания Cymer из Сан-Диего, первый прототип своего излучателя (с не слишком устойчивой генерацией и выходной мощностью всего 30 Вт) продемонстрировала в 2007 г., а на 250-Вт рубеж высокостабильного излучения вышла в 2014-м. С тех пор прошло уже больше десятка лет — странно было бы предполагать, чтобы хотя б в научных лабораториях этим направлением перестали интересоваться. 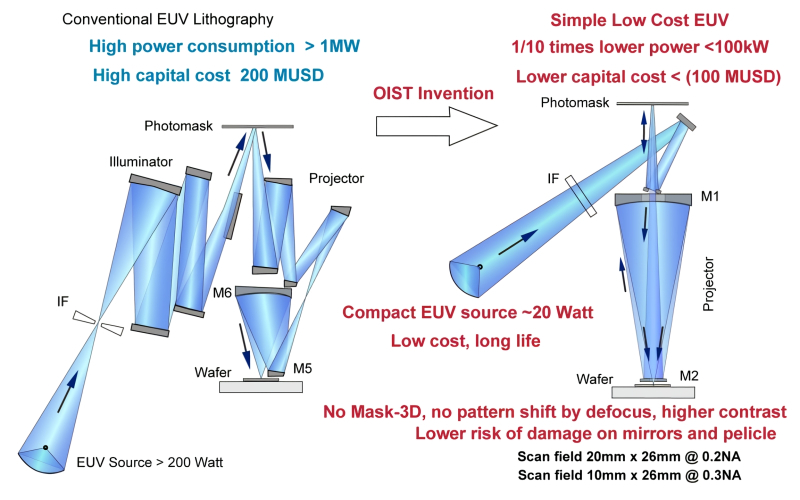
Слева — схема пути EUV-излучения, что выходит из стандартного для машин ASML углекислотно-оловянного источника и передаётся на пластину-заготовку через весьма сложную систему отражателей, по большей части асферических. Справа — предложенная японцами упрощённая конструкция: источник понадобится компактнее и эффективнее, отражателей — меньше, себестоимость выйдет ниже (источник: OIST) А никто и не переставал: летом 2024 г. в Окинавском институте науки и технологий (Okinawa Institute of Science and Technology, OIST) предложили существенно упрощённую схему генерации и доставки излучения для EUV-фотолитографии — вместо каскада асферических зеркал сделав ставку на осесимметричные зеркала с отверстиями в центре, сквозь которые проходит концентрируемый оптической системой поток излучения (схожим образом, кстати, веками строят астрономические телескопы-рефлекторы). Потери на каждом зеркале за счёт неизбежного поглощения жёстких EUV-фотонов достигают 40%, так что чем меньше зеркал в тракте прохождения пучка — тем лучше. Японские инженеры уверяют, будто рассчитанная ими схема позволит обойтись источником EUV-излучения с десятикратно меньшей мощностью, чем актуальные ныне LPP (где, напомним, CO2-лазер превращает в плазму оловянные капли размерами в десятки микрон), по себестоимости окажется выигрышнее примерно вдвое, а заодно снимет целый ряд прикладных инженерных проблем вроде повышенного износа зеркал и защищающей фотомаску плевы из-за оседания на те частиц олова (да, не все они выдуваются водородным потоком) или попутной дефокусировки многократно отражённого от зеркал сложной формы излучения. Конструкция выглядит чрезвычайно привлекательной, у неё лишь два недостатка: на практике она не воплощена даже в лаборатории (для подтверждения своих идей исследователи воспользовались компьютерной моделью) и откуда именно взять 20-Вт высокостабильный источник 13,5-нм излучения, японские инженеры не поясняли. Впрочем, как раз последний вопрос уже в меньшей степени смущает их китайских коллег: те вовсю разрабатывают новые версии EUV-лазера, в комплекте с которыми столь прямолинейная (несколько неудачный каламбур, согласны) схема прохождения пучка может оказаться настоящей находкой. В начале 2025-го команда из Харбинского политехнического университета под руководством профессора Чжао Юнпэна (Zhao Yongpeng) отчиталась о создании компактного и эффективного EUV-источника на основе технологии LDP — laser-induced discharge plasma, индуцированной лазером разрядовой плазмы. Здесь нет необходимости ронять оловянные микрокапли перед источником первичного излучения: схожий по конструкции с применяемым в LPP-машине CO2-лазер в случае LDP воздействует на электроны и ионы олова, что образуются в результате электрического разряда — пробоя между двумя металлическими электродами. Профессор Юнпэн утверждает, что излучение с базовой длиной волны 13,5 нм таким образом уже получено — и что с технической стороны LDP-блок генерации EUV-пучка заметно привлекательнее нынешнего стандарта де-факто, LPP: конструкция в целом выходит проще и компактнее, энергоэффективность её выше и за счёт более экономного расходования материалов производственные затраты на неё в составе реальной установки должны оказаться более щадящими. Косвенным подтверждением тому, что харбинская разработка — не просто многообещающий прототип, можно считать появившиеся весной 2025 г. сообщения о готовности китайских микроэлектронщиков начать предсерийный выпуск локализованных по максимуму (если не вообще полностью) EUV-фотолитографов уже в III квартале текущего года; выход же на серийную их сборку с поставкой готовой продукции заказчикам — в первую очередь, ясное дело, ведущему в КНР чипмейкеру SMIC — намечен на 2026-й. 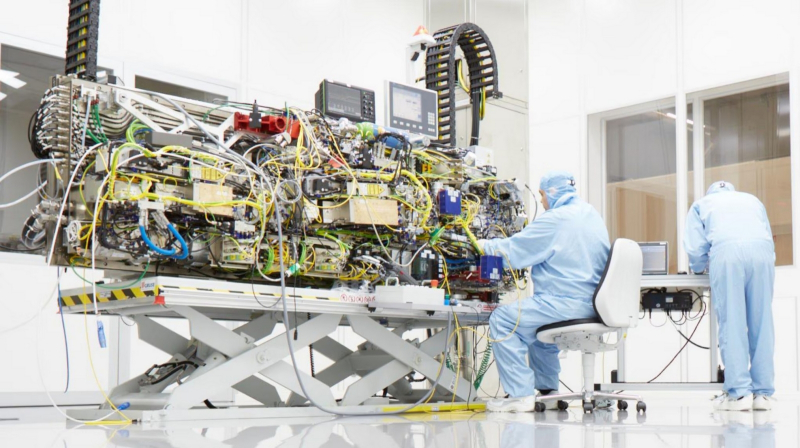
Модуль HPSM (High Power Seed Module) содержит два затравочных CO2-лазера (seed lasers), которые генерируют импульсы всего лишь по несколько ватт, а затем уже особый усилитель поднимает мощность излучения до необходимой для превращения оловянных микрокапелек в плазму (источник: TRUMPF) Кстати, у снижения потребной для изготовления нынешних микросхем мощности EUV-источника есть ещё один важный плюс с точки зрения экстенсивного, как это ни странно, развития полупроводниковой фотолитографии. Чем выше мощность светового потока, что добирается в итоге до слоя фоторезиста на пластине-заготовке, тем (с определёнными оговорками) более тонкие и/или глубокие структуры на поверхности кремниевой пластины удаётся формировать, в том числе за несколько проходов. По этой причине в планах ASML — масштабирование уже прекрасно отработанных ими LPP-источников до 1 кВт выходной мощности, что должно позволить — не меняя всех прочих узлов литографической машины — дойти примерно до «1,5-нм» технологического предела, а то и чуть глубже. Если же поменять фотонный тракт на более компактный и менее энергоёмкий — в LDP-варианте, скажем, — то запас мощности источника фотонов окажется заведомо больше; а, следовательно, есть надежда с минимальными модификациями всех прочих компонентов фотолитографа подобраться вплотную и к «1-нм» рубежу. Мало того: в КНР уже активно идёт работа — по крайней мере, теоретическая — по созданию твердотельного EUV-лазера для полупроводниковых производств. Руководит этим направлением в Шанхайском институте оптики и точной механики, что интересно, ранее занимавшийся научными исследованиями в ASML специалист по источникам света и метрологии Линь Нань (Lin Nan), который вернулся в КНР ещё в 2021 г., — между прочим, ученик Анн Л’Юилье (Anne L'Huillier), получившей в 2023 г. с коллегами Нобелевскую премию по физике за экспериментальные методы генерации аттосекундных импульсов света для изучения динамики электронов в веществе. Соединение сравнительно маломощного (до 10 Вт) твердотельного 13,5-нм лазера с оптимизированной по окинавскому принципу схемой передачи потока фотонов на пластину-заготовку может оказаться тем самым «дешёвым и сердитым» вариантом модификации EUV-технологии, которая — пока безо всякого High-NA — позволит КНР резким скачком сократить отставание от США и использующих их патенты стран в полупроводниковой отрасли до одного, максимум двух поколений технологических процессов. ⇡#Без единого гвоздяНа твердотельный же лазер сделали ставку и отечественные разработчики из Зеленоградского нанотехнологического центра (ЗНТЦ), которые в сотрудничестве с белорусскими коллегами из ОАО «Планар» завершили опытно-конструкторские работы по созданию первого отечественного фотолитографа (он же сканер, он же степпер, а если по всей строгости официальной документации, то «установка совмещения и проекционного экспонирования») с фактическим (маркетинговые, в кавычках, наименования техпроцессов начинаются примерно с «40 нм») разрешением 350 нанометров. Первые сообщения об этой разработке — машине массой 3,5 тонны и габаритами 2,0×2,6×2,5 м (это только оптико-механический узел; управляющий комплекс монтируется отдельно) — начали появляться около года назад, а весной 2025-го она была принята Государственной комиссией, то есть по сути признана годной к серийному изготовлению. Сейчас специалисты предприятия адаптируют её к применяемым потенциальными (а, может быть, уже и заключившими контракты, — достоверной информации об этом нет) заказчиками технологическим процессам, которые у каждого чипмейкера так или иначе отличаются, даже если они применяют одни и те же литографы, — взять хотя бы не один год тянущуюся эпопею с выходом Samsung на приемлемый для поточного производства микросхем уровень выпуска годных «3-нм» кристаллов с пластины, который до сих пор остаётся ниже, чем у TSMC, что позже освоила эту производственную норму на формально точно таких же станках ASML: сейчас этот уровень достигает 30% у южнокорейцев, 90+% у тайваньцев. Более того, уже в 2026 г. ЗНТЦ планирует завершить разработку предсерийного образца российского фотолитографа с расчётом на почти вдвое более миниатюрные, 130-нм производственные нормы. Понятно, что ни о каком EUV, High-NA или нет, у изделия ЗНТЦ речи не идёт, однако считать отечественный степпер прямой калькой архаичных (начало коммерческого применения которых относится к 1995 г.) машин производства всё той же ASML — то бишь рабским повторением давно пройденного — было бы опрометчиво. Эксперты, в том числе западные, справедливо отмечают скудость и недетализированность официальной информации о первом российском фотолитографе, и это вполне объяснимо — в нынешних реалиях кто владеет информационными технологиями, владеет миром, а без суверенной элементной базы самые изощрённые инженерные и программные решения обеспечивают лишь эфемерное превосходство (живой пример — страдающая вот уже который год от недоразвитости этой самой базы на родной американской почве Intel). Напомним, что в своё время 350-нм фотолитографический процесс ASML полагался на ртутные УФ-лампы с рабочей длиной волны 365 нм (варианты с 405 и 436 нм тоже применялись, но реже) и 200-мм в диаметре пластины-заготовки, а с переходом на 130-нм производственную норму в оборот вошли фторидаргоновые (ArF) 193-нм лазеры — которые использовались затем для всех последующих нод глубокой ультрафиолетовой (deep ultraviolet, DUV) фотолитографии. 350-нм степпер ЗНТЦ и «Планара» впервые в отечественной практике перешёл к использованию 200-мм кремниевых пластин (впрочем, он может работать и с применяющимися до сей поры 150-мм), а также к значительно более крупному рабочему полю — тому участку на заготовке, который за один проход засвечивает через фотомаску лазерный излучатель: теперь это 22×22 мм (а прежде было почти на порядок по каждой из сторон меньше — 3,2×3,2 мм). Для DUV-степперов ASML стандартный размер маски — 152×152 мм, что с учётом 4-5-кратного уменьшения этих габаритов при прохождении светового потока через оптическую систему даёт рабочее поле чуть больше чем 30 × 30 мм, — тоже вполне сопоставимая величина. 
Улыбчивый голландский рабочий монтирует эксимерный лазер DUV-фотолитографа — словно осознавая, что прямой угрозы его интересам иностранные разработки пока не представляют (источник: ASML) Возникает довольно логичный вопрос: если твердотельный лазер априори лучше ртутной лампы в качестве источника УФ-излучения — мощнее, энергоэффективнее, с увеличенной долговечностью и более узким спектром — и если для грядущего 130-нм литографа российские разработчики намерены взять за основу конструкцию нынешнего 350-нм (надо полагать, оставляя всё тот же твердотельный лазер, только, видимо, с иной длиной волны, — информации об этом нет никакой: сказано лишь, что «планируется разработать с нуля полностью отечественный лазер с длиной волны 193 нм» — скорее всего, силами того же российского производителя лазеров «ЛАССАРД», что выполнил нынешний твердотельный), почему же тогда мировая DUV-фотолитография (не только ASML, но и разработавшие аналогичные степперы Canon и Nikon) десятилетиями полагалась и продолжает полагаться на импульсные эксимерные ArF-лазеры? Первое приходящее на ум соображение, разумеется, экономическое: за те самые десятилетия изготовление, обслуживание и эксплуатация этих устройств генерации фотонов прекрасно отработаны, что снижает их себестоимость и упрощает работу с ними, особенно в долгой серии. Однако есть и другой, чуть менее очевидный аргумент, заодно позволяющий лучше понять, почему официальные сообщения о технологическом прорыве ЗНТЦ и «Планара» не содержат никакой значимой информации о характеристиках применённого в отечественном 350-нм фотолитографе твердотельного лазера. Появляется же этот аргумент в ходе анализа другого анонса весны 2025 г. — о создании исследователями из Академии наук КНР 193-нм лабораторного прототипа твердотельного лазера как раз с прицелом на применение его в полупроводниковом производстве. Эксимерные газовые лазеры формируют 193-нм излучение чрезвычайно короткими импульсами — с частотой 8-9 кГц, — создавая пучок DUV-фотонов мощностью 100-120 Вт. У китайского же твердотельного генератора когерентного излучения рабочим телом служит иттриево-алюминиевый гранат, легированный иттербием (ytterbium-doped yttrium aluminum garnet, Yb:YAG crystal), который дает на выходе поток 1030-нм фотонов. Проходя сквозь сложную систему с разделением пучков и с участием нелинейных оптических элементов, этот поток преобразуется в 193-нм лазерный луч — с частотой 6 кГц и шириной линии менее 880 МГц, что вполне соответствует индустриальным стандартам микропроцессорной отрасли, — но мощностью всего 70 мВт. Разница с эксимерным газовым лазером — три с гаком десятичных порядка, и с практической точки зрения это если не приговор новой технологии (в конце концов, речь о лабораторном прототипе — демонстраторе возможностей), то уж определённо указание на крайне широкий фронт предстоящих исследователям работ. И если предположить, что инженерам Союзного государства удалось решить проблему принципиально невысокой мощности твердотельных DUV-лазеров (или даже просто УФ-лазеров) по сравнению с эксимерными, это становится крайне существенным козырем в активно ведущейся прямо сейчас глобальной игре за достижение подлинного суверенитета в полупроводниковой отрасли — и действительно заслуживает засекречивания хотя бы на ранних этапах освоения технологии. 
Безмасочная литография ближнего поля как перспективный вариант принципиально иного подхода к микроэлектронному производству: a) различные изображения на экранах, собранных из ультрафиолетовых светодиодов микронных размеров (320×140 элементов); b) и c) — образы на фоторезисте, оставленные различными по длительности засветками таких экранов с габаритами рабочего поля 100×100 мкм в первом случае и 10×10 мкм во втором (источник: Nature Briefing) В этом свете поставленные правительством РФ цели освоить «28-нм» технологию к 2027 г. и «14-нм» производственные нормы к 2030-му уже не выглядят откровенным прожектёрством: в конце концов, путь от коммерческих 350 нм к 130 нм мировая микропроцессорная индустрия преодолела за шесть лет, с 1995-го по 2001-й, и, если ЗНТЦ с коллегами готовы сделать аналогичный рывок всего за год, вполне вероятно, что и десятилетие, которое занял трансфер технологий к «22-нм» ноде (серийное производство чипов по этому процессу стартовало в 2011-м), тоже удастся пробежать сопоставимо быстрее. Не следует забывать, что как раз в 2001 г., после приобретения компании Silicon Valley Group, ASML сконцентрировала в своих руках наиболее передовые наработки по теме EUV и тем самым фактически устранила из гонки за грядущие техпроцессы весьма сильных на тот момент конкурентов, Canon и Nikon. С каждым годом обретая всё более зримые черты монополиста на рынке фотолитографического оборудования для производства полупроводников, голландская компания получила эффективную возможность удерживать темпы технологического прогресса в рассматриваемой области на приемлемом для себя уровне, развивая DUV «в час по чайной ложке», — с тем, чтобы снимать максимум сливок с экстенсивно растущего направления, направляя заработанные сверхприбыли на опережающее развитие всё того же самого EUV. Не скованные подобного рода монополистическими соображениями — наоборот, подхлёстываемые стремлением обеспечить своим странам подлинный полупроводниковый суверенитет в условиях острейшего соперничества, — и российские, и китайские разработчики наверняка сумеют за разумное время одолеть отрезающую их ныне от обетованной земли EUV пропасть. А в ответ, надо полагать (если, конечно, к тому времени глобальный ныне ИТ-рынок не развалится на принципиально, на уровне стандартов и протоколов, не совместимые фрагменты), и американские инженеры вместе с той же ASML интенсифицируют свои усилия по дальнейшему совершенствованию High-NA EUV — в стремлении не просто не отстать, но сохранить своё нынешнее лидерство. Вот тогда, ориентировочно как раз к началу 2030-х, и станет окончательно ясно, будут ли микроэлектронщики штурмовать «нанометровый» предел с применением актуальных ныне EUV-инструментов той или иной степени модернизации, или же выберут менее очевидный сегодня путь — вроде уже упоминавшихся безмасочных литографов на высокоэнергетических фотонах, ионно-лучевых или же наноимпринтных агрегатов. Так или иначе, всё туже затягивающийся ныне на шее микропроцессорной индустрии EUV-узел окажется либо тщательно развязан, либо лихо разрублен, — в зависимости от того, какой подход на практике проявит наибольшую эффективность. ⇡#Материалы по теме
Если Вы заметили ошибку — выделите ее мышью и нажмите CTRL+ENTER.
|